方案详情
文
GaN因其宽禁带(3.4~6.2 eV)、高电子迁移率(2.8×107 cm/s)、高临界击穿场强(≥5 MV/CM)和高热导率(1.3 W/(cm∙K))等物理特性而在微波射频、高功率电子器件等领域应用广泛,其中GaN 基HEMT器件更是成为了半导体器件领域的研究热点。
方案详情

GaN MOS-HEMT器件异质结界面的无损深度分析关键词:凹槽栅、MOS-HEMT、Al2O3/GaN、界面工程、HAXPESGaN因其宽禁带(3.4~6.2 eV)、高电子迁移率(2.8×107 cm/s)、高临界击穿场强(≥5 MV/CM)和高热导率(1.3 W/(cm∙K))等物理特性而在微波射频、高功率电子器件等领域应用广泛,其中GaN 基HEMT器件更是成为了半导体器件领域的研究热点。图1. (a) GaN结构示意图, (b) GaN、SiC和Si材料特性比较。GaN HEMT器件的核心结构是AlGaN/GaN异质结,其界面处由于自发极化效应和压电极化效应会产生高浓度的二维电子气(2DEG),使器件处于导通状态。 可通过在栅极与AlGaN 之间引入绝缘介质作为栅介质和钝化层,制备成凹槽全刻蚀增强型MOS HEMT 器件(见图2-左),可以有效改善肖特基栅HEMT器件栅极漏电大、栅压摆幅小和电流崩塌严重等问题。图2. (左)MOSc-HEMT的示意图;(右)MOS-1和MOS-2的原理图和工艺流程。[2]然而,基于原子层刻蚀及原子层沉积技术制备出的凹槽栅增强型GaN MOS-HEMT 功率器件,由于表面悬挂键、界面氧化以及制备过程中的刻蚀损伤等所致而普遍存在界面态问题,从而引起器件阈值电压不稳定和迟滞,在实际电子电路应用中会影响电路模块和系统的稳定性及可靠性。因此,界面质量的好坏直接影响器件栅极漏电、阈值电压稳定性和击穿电压等问题,界面工程以及界面表征对提高器件的性能至关重要。对此,法国CEA Leti研究人员对GaN基凹槽栅MOS-HEMT器件进行了创新性的界面处理(工艺流程见图2-右),制备了具有高界面质量的GaN基凹槽栅MOS-HEMT器件。为了进一步探究了造成界面缺陷电荷和迟滞现象变化的原因,采用相同的工艺条件下制备了Al2O3厚度仅为15 nm的Al2O3/GaN特定样品,借助HAXPES(PHI Quantes,同时搭载了Al Kα和Cr Kα)对界面处进行了元素组分和化学态分析。值得注意但是,常规XPS的分析深度小于10 nm,而Cr Kα(HAXPES)的分析深度大约是其3倍,利用Cr Kα可以不借助离子溅射技术直接探测20 nm左右埋层界面的原始的信息。在本研究中,Cr Kα对该样品的综合采样深度约为16.6 nm(TOA=45°)和24 nm(TOA=90°),结果如图3所示。Ga 2p谱图中Ga-O(~1118.4 eV)所在的峰代表了界面处GaN的氧化。O 1s的贡献来自于O-Al(~531 eV)和O-H(~532.2 eV),后者证明且量化了氧化镓中O-H基团的存在。图3. HAXPES:Ga 2p3/2(TOA=45°)、O 1s(TOA=90°)。[1]不同PDA(沉积后退火)温度下的HAXPES结果表明Ga-O键与界面处氧化镓(GaOX)的存在有关,且随着温度的升高而降低,但温度高于500℃后Ga-O含量会再次增加(见图4)。此外,Al2O3中的O-H基团含量随着PDA温度的升高而减少。二者分别对应的C-V测试中迟滞率升降的变化与Ga-O和O-H的变化趋势一致。由此,推断出迟滞率随PDA温度的升高而降低的原因是Al2O3/GaN界面处Ga-O和O-H的减少,最佳的PDA温度为500℃。图4. 不同PDA温度下Ga-O和O-H键的HAXPES结果(Ga 2p3/2:TOA=45°;O1s:TOA=90°)。[1]综上,PDA可以有效恢复Al2O3/GaN界面处的Ga-N键,减少界面以及绝缘层体内的缺陷电荷,提高器件的性能。此外,该工作还体现了HAXPES在半导体器件的研发和优化制造工艺中的重要作用。ULVAC-PHI作为全球领先的表面分析仪器制造商,一直致力于开发先进的表面分析设备以及提供优质的可靠的技术服务。如今,ULVAC-PHI推出了新一代的XPS设备---PHI GENESIS,可同时搭载常规XPS(Al Kα)和HAXPES(Cr Kα),以及UPS、LEIPS、SAM(AES)等,打造了全面高性能的电子结构综合分析平台,推动了相关领域科研和企业的发展。缩略语对照表:2DEG:two-dimensional electron gas (二维电子气)MOS HEMT:Metal-Oxide-Semiconductor High Electron Mobility Transistor (金属-氧化物-半导体 高电子迁移率晶体管)HAXPES:Hard X-Ray Photoelectron Spectroscopy (硬X射线光电子能谱)PDA:Post-Deposition Anneal (沉积后退火处理)参考文献 [1] Rocha, PFPP., et al., Impact of post-deposition anneal on ALD Al2O3/etched GaN interface for gate-first MOSc-HEMT. Power Electronic Devices and Components 4 (2023) 100033. DOI: 10.1016/j.pedc.2023.100033.此处插入联系我们
确定
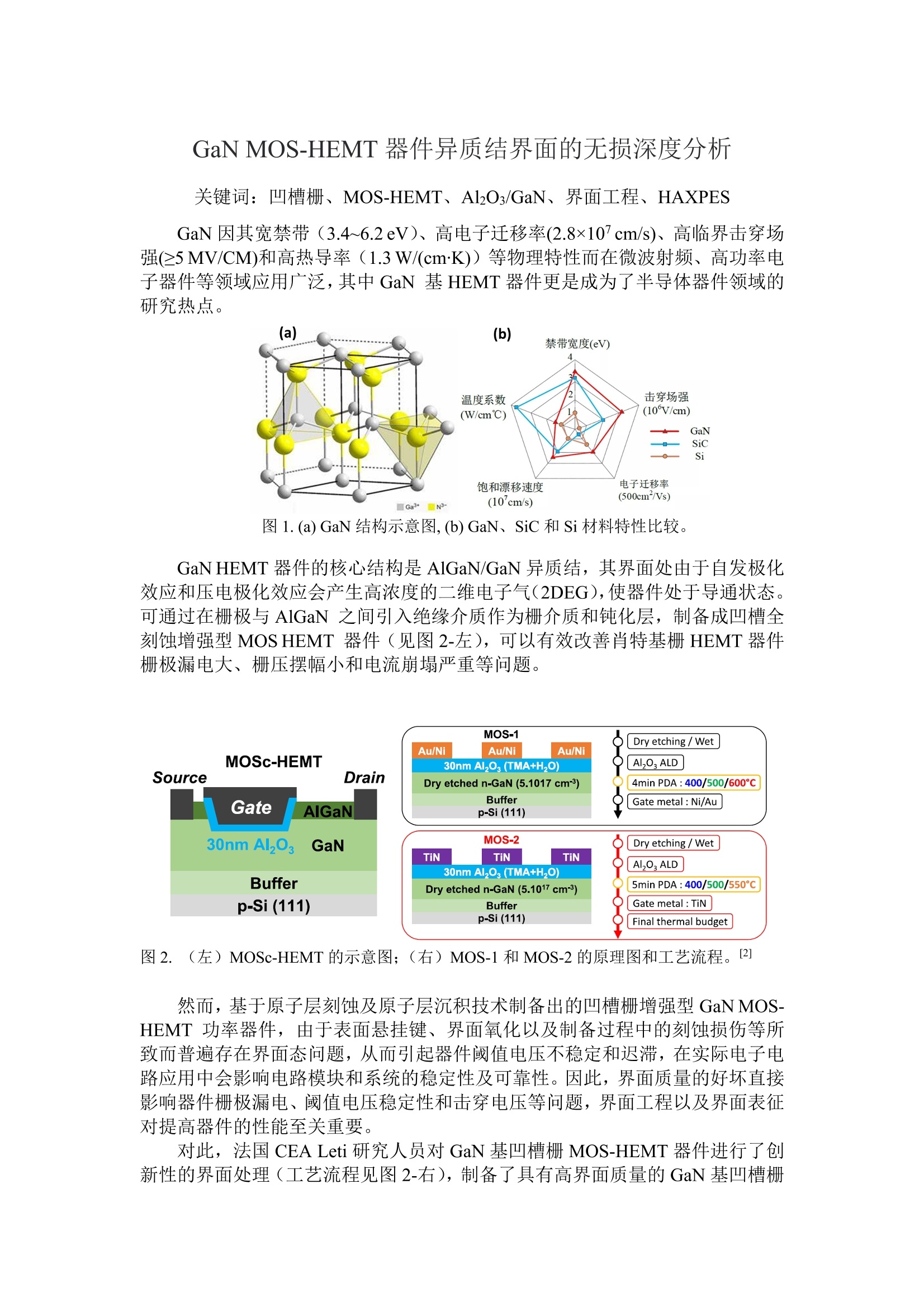


还剩1页未读,是否继续阅读?
爱发科费恩斯(南京)仪器有限公司为您提供《GaN MOS-HEMT器件异质结界面的无损深度分析》,该方案主要用于半导体材料中半导体器件检测,参考标准--,《GaN MOS-HEMT器件异质结界面的无损深度分析》用到的仪器有PHI 硬X射线光电子能谱仪、PHI X射线光电子能谱仪
相关方案
更多











