Avantage 软件配有丰富的 XPS 相关数据处理功能,其中带隙测量便是功能之 一。该功能提供了一种能量损失初始位置的自动测量方法。此种方法是建立在 “光电子先进行物质带隙的克服随后才会出现非弹性能量损失现象”的假设基础 上,通过对能量损失峰进行拟合和进一步的斜率计算得到能量损失的起始位置 进而求得带隙。
方案详情

操作指南|Avantage软件之带隙测量功能 赛默飞材料与结构分析中国 摘要 Avantage 软件配有丰富的 XPS 相关数据处理功能,其中带隙测量便是功能之一。该功能提供了一种能量损失初始位置的自动测量方法。此种方法是建立在“光电子先进行物质带隙的克服随后才会出现非弹性能量损失现象”的假设基础上,通过对能量损失峰进行拟合和进一步的斜率计算得到能量损失的起始位置进而求得带隙。 前言 随着半导体材料、电子材料、集成电路行业的飞速发展,由于带隙参数能反应出材料价带信息,所以人们对带隙测量也越来越关注。Avantage 软件具有强大的 XPS 数据处理能力,其中带隙测量便是其功能之一,能快速测量出带隙。该功能可以自动测量能量损失初始位置,通过对能量损失峰进行拟合和进一步的斜率计算得到能量损失的起始位置进而求得带隙。本文就介绍如何通过 XPS 来快速测试样品带隙。 测试仪器和测试方法 选择ESCALAB Xi*光电子能谱仪进行测试,仪器外观见图1。为消除样品荷电效应开启标准模式的中和枪。测试时采用常规 XPS测试参数即可,如单色化X射线源,500微米束斑。 图1 ESCALAB Xi+ X射线光电子能普仪 适用范围 该测量方法主要适用于单个化学态谱峰,而不适用于多个化学态的谱峰。如SiOz/Si 基底上不同厚度 Al2O3样品,利用各样品O1s 谱峰确定能量损失峰的起始位置,从而可进行带隙的测量。SiOz/Si 基底上不同厚度 Al2O3样品的O1s 谱图及带隙求取示例如图2所示,最终利用 XPS 测试求取出对应的带隙数值随Al203样品厚度的变化示意图,如图3所示。 图2 SiO,/Si基底上不同厚度AI,O,样品的O1s谱图及带隙求取示例 图3利用XPS求取出对应的带隙数值随AL,O,样品厚度的变化 利用O1s窄扫谱图计算带隙的操作方法 图4 Band Gap Measurement调出界面 先点击选中对应的O1s谱图,如上图所示,点击软件的 Analysis—Band GapMeasurement即可调出。点击后会出现以下对话框,如下图5所示。 图5利用O1s求取带隙对话框示例 上图对话框中的相应参数可以进行人为的修改,但建议在进行测量时采用相同参数进行测量,以免由于参数改变而引入一定的测量误差,该功能的大致计算流程为: ·数据首先经过平滑处理得到谱峰最低点的峰位(即峰谷),即“Dip”; ·“Max Distance”参数是将距峰谷处特定距离的谱峰数据进行分离,并对其进行拟合以及进一步斜率的计算(数值过大会影响真实的能量损失结构,数值过小将会导致计算结果误差较大); ·最小线宽是指线允许的最小数值,拟合程序将会调整谱线对应的能量宽度。由上图可以看出,选中相应图谱调出 Band Gap Measurement 界面后,调整相关 参数, Avantage 软件便会自动算出材料带值值,方便快速。 利用 REELS 图谱(反射电子能量损失谱)求取带隙案例展示 对于带隙的求取,同样可以利用 REELS 数据进行求取,求取步骤同上,下图为计算示意图,如图6所示。 图6利用REELS数据求取带隙对话框示例 结论 本文介绍了用 Avantage 软件求取带隙的功能。可看到, Avantage 软件不仅具有强大的 XPS 数据处理能力,同时还是一个全面的数据分析软件。通过Avantage 软件能快速得完成料材料带隙的测量求取,满足客户测试带隙的需求,助力半导体材料、电子材料、集成电路行业的发展。
确定

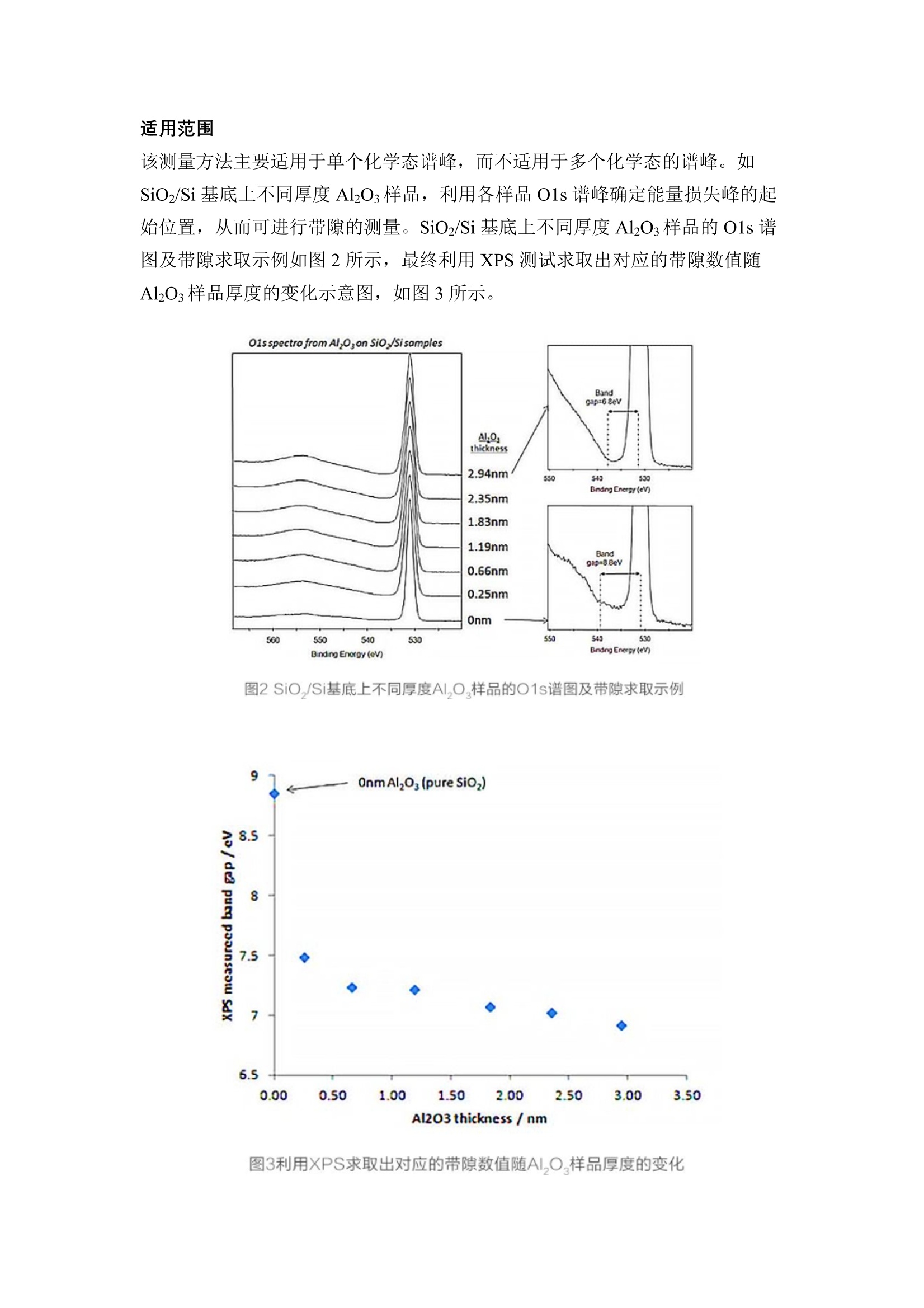

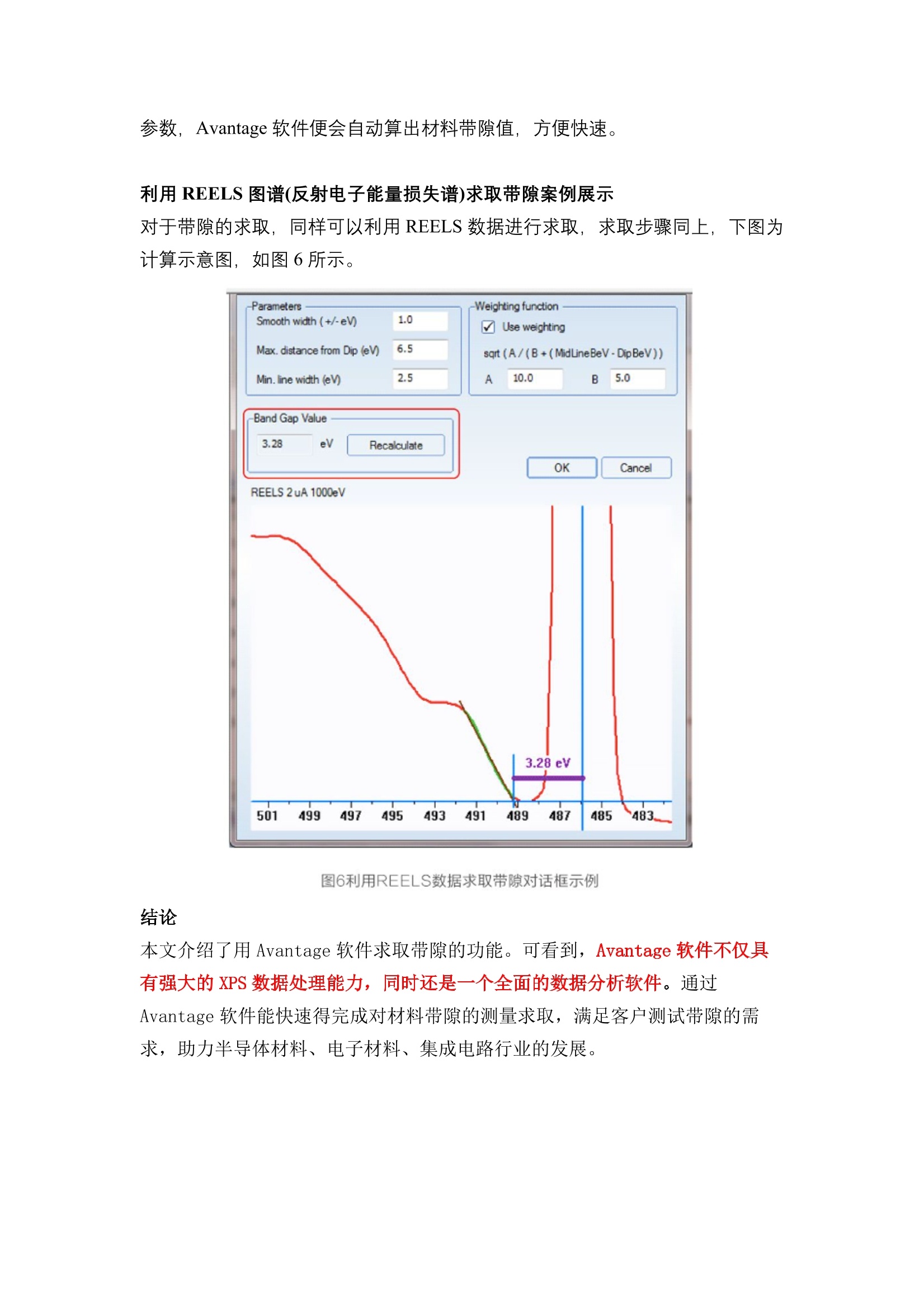
还剩2页未读,是否继续阅读?
赛默飞世尔科技元素分析(Elemental)为您提供《半导体材料、电子材料、集成电路中材料带隙检测方案(X光电子能谱)》,该方案主要用于其他中材料带隙检测,参考标准--,《半导体材料、电子材料、集成电路中材料带隙检测方案(X光电子能谱)》用到的仪器有
相关方案
更多










