推荐厂家
暂无
暂无
 白金8年
白金8年
 400-801-8191
400-801-8191
 留言咨询
留言咨询
 留言咨询
留言咨询
 留言咨询
留言咨询

 400-860-5168转4527
400-860-5168转4527
 留言咨询
留言咨询

 400-801-8191
400-801-8191
 留言咨询
留言咨询

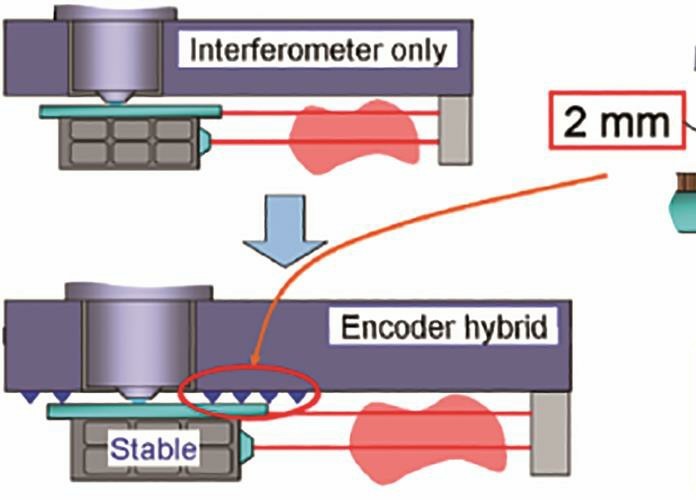





应用方面有什么基本的区别?另外实验室想买一套电子束光刻设备,有什么好的推荐?
光刻机通过一系列的光源能量、形状控制手段,将光束透射过画着线路图的掩模,经物镜补偿各种光学误差,将线路图成比例缩小后映射到硅片上,不同光刻机的成像比例不同,有5:1,也有4:1。然后使用化学方法显影,得到刻在硅片上的电路图(即芯片)。一般的光刻工艺要经历硅片表面清洗烘干、涂底、旋涂光刻胶、软烘、对准曝光、后烘、显影、硬烘、激光刻蚀等工序。经过一次光刻的芯片可以继续涂胶、曝光。越复杂的芯片,线路图的层数越多,也需要更精密的曝光控制过程。现在最先进的芯片有30多层。http://www.whchip.com/upload/201608/1471850877761920.png 上图是一张光刻机的简易工作原理图。下面,简单介绍一下图中各设备的作用。测量台、曝光台:承载硅片的工作台,也就是本次所说的双工作台。光束矫正器:矫正光束入射方向,让激光束尽量平行。能量控制器:控制最终照射到硅片上的能量,曝光不足或过足都会严重影响成像质量。光束形状设置:设置光束为圆型、环型等不同形状,不同的光束状态有不同的光学特性。遮光器:在不需要曝光的时候,阻止光束照射到硅片。能量探测器:检测光束最终入射能量是否符合曝光要求,并反馈给能量控制器进行调整。掩模版:一块在内部刻着线路设计图的玻璃板,贵的要数十万美元。掩膜台:承载掩模版运动的设备,运动控制精度是nm级的。物镜:物镜由20多块镜片组成,主要作用是把掩膜版上的电路图按比例缩小,再被激光映射的硅片上,并且物镜还要补偿各种光学误差。技术难度就在于物镜的设计难度大,精度的要求高。硅片:用硅晶制成的圆片。硅片有多种尺寸,尺寸越大,产率越高。题外话,由于硅片是圆的,所以需要在硅片上剪一个缺口来确认硅片的坐标系,根据缺口的形状不同分为两种,分别叫flat、notch。内部封闭框架、减振器:将工作台与外部环境隔离,保持水平,减少外界振动干扰,并维持稳定的温度、压力。
[b]微流控芯片光刻机[/b]专业为[b]微流控芯片制作[/b]而设计,用于[b]刻画制作微结构[/b]表面,全自动化和可编程操作,适合几乎所有常用材料。[b]微流控芯片光刻机[/b]采用多功能一体化设计理念,一台光刻机具有六个传统单一的表面刻划机器的功能,而且不需要无尘环境,用户安装使用不再需要单独建设超净间,从而大大提高用户的使用经济性和方便性。[b][url=http://www.f-lab.cn/microarray-manufacturing/lithography.html]微流控芯片光刻机[/url]特色[/b]可以根据用户的芯片衬底基片尺寸,形状和厚度进行调节。是一种无掩模光刻系统,具有两个易操作的软件,用户可以创建个人微结构图案,从单个微通道到复杂的微观结构都可以创建。具有技术突破性设计和灵活性优势,非常适合加工微纳结构用于MEMS,BioMEMS,微流控系统,传感器,光学元件,MicroPatterning微图案化,实验室单芯片,CMOS传感器和所有其他需要微结构的应用。[img=微流控芯片光刻机]http://www.f-lab.cn/Upload/photolithography-MS10.JPG[/img]无掩模光刻系统可以快速而轻松地做出许多种微图案结构,从最简单到非常复杂的都可以。它的写入磁头装备有一个激光二极管(波长405纳米- 50毫瓦),光学扫描器和F-θ透镜(405纳米)。激光束根据设定微结构图案而运动。为了方便使用,较好的再现性和较高的质量,焦距是可以根据基片厚度进行调节的。图像采集期间可以使用控制面板调节焦距。几个基片厚度都可以使用。编程参数被保存以供以后使用,修改或其他用户使用。[img=微流控芯片光刻机]http://www.f-lab.cn/Upload/microcontact-printing.JPG[/img]微流控芯片光刻机:[url]http://www.f-lab.cn/microarray-manufacturing/lithography.html[/url]


