







半导体&电子测试测量,投稿:kangpc@instrument.com.cn


近日,德州仪器半导体制造(成都)有限公司凸点加工及封装测试生产扩能项目(二期)竣工验收。该二期工程建设内容包括:在集成电路制造厂(FABB)新增凸点加工产能18.7975万片/年(全为常规凸点产品),在封装测试厂(AT)新增封装测试产能 10 亿只/年(均为常规QFN产品)。二期工程建设完成后,扩能项目新增凸点加工产能33.3975万片/年(全部为常规凸点33.3975万片/年),新增封装测试产能 21.48 亿只/年(其中常规QFN 15.48 亿只/年,WCSP 6 亿只/年)。
仪器信息网通过公开文件查阅到该项目的相关仪器设备配置清单和工艺流程。
FABB 集成电路制造厂主要生产设备清单

.


封装测试厂(AT)主要生产设备清单



生产工艺:
1、凸点加工
晶圆凸点是在封装之前完成的制造工艺,属于先进的封装技术。该工艺通过在晶圆级器件上制造凸点状或球状结合物以实现接合,从而取代传统的打线接合技术。凸点加工制程即从晶圆加工完成基体电路后,利用涂胶、黄光、电镀及蚀刻制程等制作技术通过在芯片表面制作铜锡凸点,提供了芯片之间、芯片和基板之间的“点连接”,由于避免了传统 Wire Bonding 向四周辐射的金属“线连接”,减小了芯片面积,此外凸块阵列在芯片表面,引脚密度可以做得很高,便于满足芯片性能提升的需求,并具有较佳抗电迁移和导热能力以及高密度、低阻抗,低寄生电容、低电感,低能耗,低信噪比、低成本等优点。 扩能项目凸点包括普通凸点和 HotRod 凸点两种,其主要区别在于凸点制作所采用的焊锡淀积技术不同,普通凸点采用植锡球工艺,工艺流程如下图所示,Hot Rod 凸点采用电镀锡银工艺,工艺流程如下图所示。扩能项目凸点包括 RDL(Redistribution Layer)、BOP-on-COA(Bump on Pad – Copper on Anything)、BOP(Bump on Pad)、BOAC (Bond Over Active Circuit)、 BOAC PI (Bond Over Active Circuit with Polyimide)、Pb-free HotRod,上述各类凸点结构如下图所示,主要区别为层次结构和凸点类型不同。
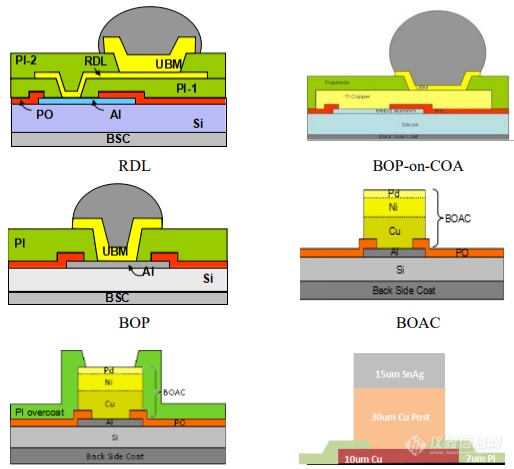
扩能项目各类凸点结构示意


普通凸点加工主要工艺流程及产污环节
注:普通凸点产品中的 BOAC 不含灰化、回流焊与助焊剂去除工艺



Hot Rod 凸点加工主要工艺流程及产污环节
凸点加工的主要工艺流程简述如下:
(1)晶圆检测分类(wafer sorting):对来料晶圆进行检测,主要是检测晶圆有无宏观缺陷并分类。
(2)晶圆清洗(incoming clean):由于半导体生产要求非常严格。扩能项目清洗工艺分为两种工艺,第一种仅使用高纯水,另一种使用 IPA 清洗,清洗后再用纯水进行清洗。IPA 会进入废溶剂作为危废收集,清洗废水进入中和废水系统进行处理。
(3)烘干(Dehydration bake):将清洗后的晶圆烘干。该工序产生的烘干废气通过一般废气排气系统排放。
(4)光刻(Photo)
扩能项目采用光刻机来实现电镀掩膜和PI(聚酰亚胺)层制作,包括涂胶、曝光,EBR和显影。涂胶是在晶圆表面通过晶圆的高速旋转均匀涂上光刻胶(扩能项目为光阻液和聚酰亚胺(PI))的过程;曝光是使用曝光设备,并透过光掩膜版对涂胶的晶圆进行光照,使部分光刻胶得到光照,另外部分光刻胶得不到光照,从而改变光刻胶性质;显影之前,需要使用EBR对边缘光阻进行去除。显影是对曝光后的光刻胶进行去除,由于光照后的光刻胶和未被光照的光刻胶将分别溶于显影液和不溶于显影液,这样就使光刻胶上形成了沟槽。通过曝光显影后再进行烘干,晶圆表面可形成绝缘掩膜层。
扩能项目该制程使用了各类光阻液、聚酰亚胺、EBR、显影液及纯水,完成制程的废液统一收集,作为危废外运处置。显影液中由于含有四甲基氢氧化铵,将产生少量的碱性废气,由于其浓度很低,扩能项目将其通入酸性废气处理系统进行处理;显影液及显影液清洗水排入中和废水处理系统。
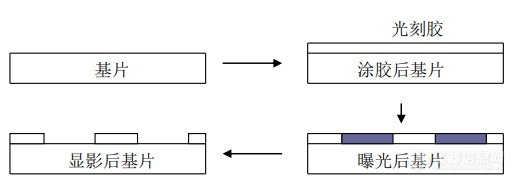
光刻工艺示意图
(5)溅射(SPUTTER)
溅射属于物理气相沉积(PVD)的一种常见方法,即金属沉积,就是在晶圆上沉积金属。UBM(凸点底层金属)是连接焊接凸点与芯片最终金属层的界面。UBM 应在芯片焊盘与焊锡之间提供一个低的连接电阻。为了形成良好的 UBM,一般采用溅射的方法按顺序淀积上需要的金属层。扩能项目采用 Ti:W 合金-Cu 的顺序进行溅射。
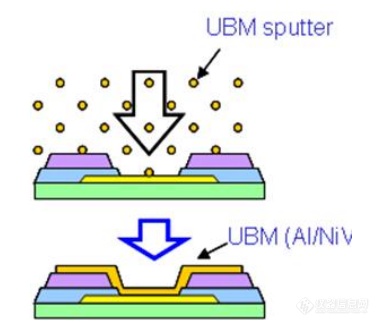
溅射示意图
(6)电镀(Plate)
凸点电镀根据需求,可单纯镀铜,也可镀铜、镍、钯或镀铜、锡银,镀层厚度也有差异,可为铜膜或铜柱。
扩能项目普通凸点电镀工艺包括镀铜膜、镀镍和镀钯。
扩能项目 HotRod 凸点电镀工艺包括电镀底层铜(plate COA,Copper on Anything)、电镀铜柱(plate Cu POST)、电镀锡银。
基本的电镀槽包括阳极、阴极、电源和电镀液。晶圆作为阴极,UBM的一部分作为电镀衬底。在电镀的过程中,铜、锡银溶解在电镀液中并分离成阳离子。加上电压后,带正电的 Cu2+、Sn2+、Ag+迁移到阴极(晶圆),并在其表面发生电化学反应而淀积出来。电镀工艺原理示意图如下:
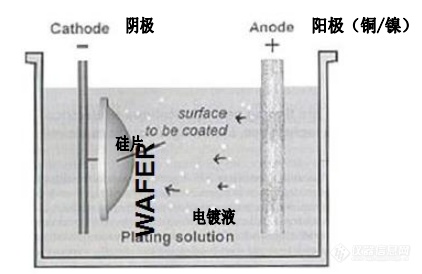
电镀工艺示意图
扩能项目采用的铜、镍阳极为颗粒状,会全部消耗,不产生废阳极;扩能项目使用的镀钯、锡银阳极是镀铂钛篮,呈网状支架作为电镀阳极,不消耗也不更换,镀银采用烷基磺酸盐无氰镀银工艺。 阳极金属如下图所示:

电镀阳极实物图
b.电镀操作过程
进机台→将每片晶圆上到杯状夹具上→用超纯水预湿→镀铜→清洗→镀锡银(或镀镍→清洗→镀钯)→清洗→甩干→出机台。
c.电镀清洗
扩能项目电镀清洗采用单槽快速喷洗,清洗水直接排入废水处理系统,不重复利用,清洗废水排入 FABB 一楼电镀废水处理系统进行处理,保证处理设施出口一类重金属排放达标。清洗过程中产生有机废气排入有机废气处理系统统一处理。
d.电镀槽液更换
项目对电镀槽中电镀液离子浓度定期检测,适时添加化学药剂,保证电镀液可用。使用一段时间后,因电镀液中悬浮物浓度升高,需对电镀液进行更换。扩能项目依托 FABB 一层现有的2个2m³的电镀废液收集槽将电镀废液全部收集暂存,委托有资质的危废处理公司外运处置。电镀废液约半年排放一次,年排放量约为 3.5m³,因此收集槽的容积可满足废液收集需求。
(7)去光阻(Resist stripping)
电镀完成后,利用光阻去除剂去除电镀掩膜光阻,依次使用 NMP 与 IPA 进行湿式清洗,最后用纯水进行清洗,清洗后进行干燥。干燥通过自燃烘干或者 IPA 吹干。
(8)蚀刻(ETCH) 将凸点间的 UBM 刻蚀掉。
扩能项目采用湿法腐蚀。湿法腐蚀是通过化学反应的方法对基材腐蚀的过程,对不同的去除物质使用不同的材料。扩能项目采用过氧化氢作为 Ti-W 合金的腐蚀材料,普通凸点采用硫酸腐蚀铜,含锡银凸点采用磷酸腐蚀铜,产生的含磷的酸性废水排入 CUB5c 氢氟废水处理系统进行处理,不含磷的酸性废水排入中和系统进行处理。蚀刻完成后,使用气体吹扫晶圆表面进行去杂质。
(9)灰化(Ash)
剥离光掩膜的过程可以使用干燥的、环保的等离子工艺(‘灰化’),即用氧 等离子体轰击光掩膜并与之反应生产二氧化碳、水等物质使其得以剥离。该过程 产生一般热排气,排入一般排气。
(10)凸点制作
晶圆凸点工艺最主要的 3 种焊锡淀积技术是电镀、焊锡膏印刷以及采用预成 型的焊锡球进行粘球。RDL、BOP、BOAC 等凸点采用粘球工艺(Ball place),粘 球的一般操作过程为,首先在晶圆表面涂抹一层助焊剂,然后将预先成型的焊锡 球沾在助焊剂上,接着进行检查,确保每个晶粒都沾有焊锡球。Hot Rod 等凸点 焊锡淀积技术采用电镀锡银工艺。
回流(reflow),该过程将焊料熔化回流,使凸点符合后续封装焊接要求。最 后,再使用纯水对助焊剂进行清洗去除(Flux wash)。助焊剂清洗废水排入中 和废水系统进行处理。
(11)自动检测(AVI)
对凸点加工完的晶圆进行自动检测,确认是否有缺陷。至此,晶圆上的凸点 制作完成。
(12)晶圆针测(Probe)
在凸点完成后,晶圆上就形成了一个个的小格,即晶粒。针测(Probe)是对每个晶粒检测其导电性,只进行通电检测操作,没有任何化学过程。不合格晶粒信息将被电子系统记录,在接下来的封装和测试流程中将不被封装。扩能项目晶圆针测工序全部在 OS5 进行。
(13)包装(Packing):
利用塑料盒、塑料袋等对完成凸点的晶圆进行简单包装,然后进入AT厂房进行封装(后工序)。
2、封装测试
QFN 封装测试
QFN 封装即倒装式四周扁平无引脚封装(QFN,Quad Flat No lead Package),扩能项目 QFN 封装包括传统 QFN 封装和 FCOL QFN 封装(Flip Chip on Lead frame QFN Package,框架上倒装芯片封装)。传统 QFN 封装和 FCOL QFN 封装的结构如图所示。
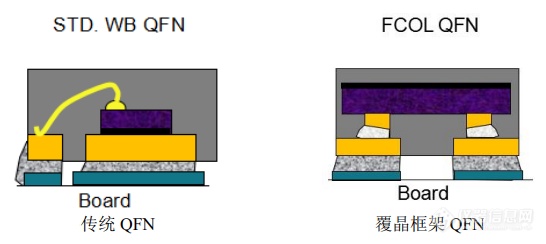
传统 QFN 封装和 FCOL QFN 封装结构对比
覆晶框架QFN在工艺流程上相较传统QFN主要区别在芯片与载板框架的连接方式,传统 QFN 通过金属导线键合,覆晶框架 QFN 通过芯片倒装凸点键合,相比传统工艺新增助焊剂丝网印刷、覆晶结合、助焊剂清洗、等离子清洗等工艺,以下对 QFN 封装的工艺及产污进行表述。
贴片:在自动贴膜机上在晶圆的正面贴一层保护膜(胶带),研磨过程中保 护晶圆的电路表面。
该工序可能产生废胶带。
(1)背面减薄:研磨机台上,通过高速旋转的研磨轮(转速约为 2500 转每
秒)对晶圆背面进行机械研磨,将晶圆减薄到规定厚度。研磨过程中需要用超纯
水冲洗研磨硅屑和冷却研磨轮。清洗废水经回收系统回收利用后,浓水排入废水
处理站进行絮凝沉淀+中和处理。
(2)去膜:研磨完成后,去除晶圆正面的胶带。该工序可能产生废胶带。
(3)晶圆清洗:利用超纯水对晶圆表面进行冲洗,去除晶圆表面的尘埃颗 粒等杂质。清洗废水经回收系统回收利用后,浓水排入废水处理站进行絮凝沉淀+中和处理。
(4)背面贴膜:使用背面贴膜设备在晶圆背面贴一层 BSC 膜,使晶圆背面被胶带保护、支撑。该工序可能产生废胶带。
(5)烘干:使用背面涂层烘烤设备将膜层烘干。
(6)贴膜:使用晶圆贴片机在晶圆的背面再贴一层膜。该工序可能产生废胶带。
(7)划片:在专门的划片机上,通过高速旋转的金刚石刀片(转速约在 50000 转每秒)或激光将晶圆切割成符合规定尺寸的晶粒(die)。刀片的金刚石颗粒 大小只有几个微米。切割过程中利用超纯水进行刀片冷却和硅屑冲洗。激光划片属非接触加工,无应力,因此切边平直整齐,无损坏;不会损伤晶圆结构,电性 参数优于机械切割方式,用超纯水进行硅屑冲洗。
(8)UV 照射:使用 UV 照射机进行 UV 照射使粘结剂失去黏性达到去膜的目的。
(9)点银浆:将银浆点到框架上以备粘合用;
(10)粘片:将芯片置入框架点银浆处;
(11)银浆固化:在氮气保护环境下烘干固化,将芯片牢固的粘结在框架上;
(12)引线键合:使用金线或铜线将芯片电路 Pad 与框架引脚 Lead 通过焊接的方法连接起来,实现电路导通,焊接采用超声波焊接,无焊接烟尘产生,主要产污为废引线。
(13)助焊剂丝网印刷:在密闭机台内用丝网将助焊剂印刷到引线金属框架上,无排气。丝网采用 IPA 清洗,清洗有有两种情况,一种是用设备自动清洗,IPA 会喷到丝网上,然后用棉布擦拭,擦拭布吸收 IPA 及丝网上的脏物后就当作 危废处理,没有废液,设备是密闭的,不连接排气;另外一种是人工擦拭,会在 化学品通风橱内操作,也是用棉布擦拭,没有废液产生,通风橱连的一般排气。
(14)覆晶结合:将晶圆 IC 反扣在引线金属框架上,让锡银铜柱对准丝网 印刷的助焊剂。
(15)回流焊:将覆晶结合后的芯片放在氮气保护的回焊炉内按一定的温度曲线通过该炉,使用回流焊的方式实现晶圆 IC 与引线金属框架的焊接,该过程使用的助焊剂无挥发性物质,后续使用专用清洗剂进行清洗。
(16)助焊剂清洗:使用助焊剂清洗剂洗掉回流焊残留的助焊剂并用水冲洗干净。设备自带清洗废气冷凝装置,冷凝液进入废水处理系统,不凝气接入现有一般排气系统。
(17)等离子清洗:使用等离子清洗剂激发氧氩等离子体实现更高级别的彻 底清洗,将残留的微量氧化层清洗干净,清洗废气接入现有一般排气。
(18)塑封固化:使用环氧树脂对 IC 进行外壳封装。
(19)去毛刺:去除塑封外壳毛刺并进一步烘烤固化成型将塑封固化好的芯片置入有机盐溶液中去除塑封外壳毛刺及溢出料,产生去毛刺废水。
(20)激光打标:用激光将产品的 Lot No 刻录在产品表面(为了追踪产品的履历)。就是在产品的表面印上去不掉的、字迹清楚的字母和标识,包括制造商 的信息、国家、器件代码,生产日期等,主要是为了产品识别并跟踪,该工序将 产生打印粉尘和硅粉。
(21)切带:切开胶带使单个晶粒分离。
(22)自动检测:使用 2/3D 自动检测设备进行检测。均为物理测试。检查 产品的电气及速度特性,包括基本测试,如电气特性可靠性测试、直流电、交流 电运行测试、目视检查,以及运行速度测试等。
(23)IC 分类:使用晶粒分类设备对封装好的晶圆进行分类。
(24)终检:使用最终检测设备进行终检。
(25)包装:使用真空包装设备对封装好的芯片进行包装并入库。该工序可能产生废包材。


传统 QFN 工艺流程及产污环节

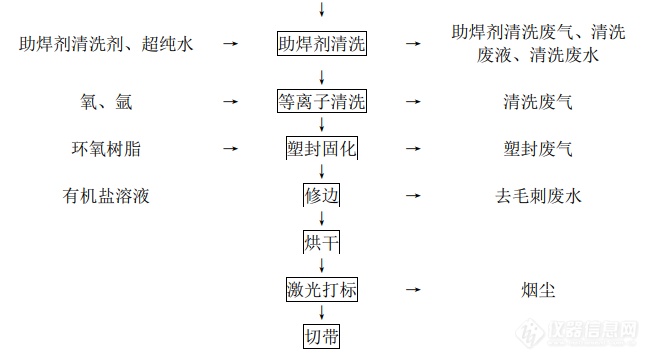
FCOL QFN 工艺流程及产污环节
2、WCSP 封装
WCSP 封装(Wafer Chip Scale Packaging,晶圆级封装),即在晶圆片未进 行切割划片前对芯片进行封装,之后再进行切片分割,完成后的封装大小和芯片尺寸相同。此外,WCSP 封装无需载板框架,可直接焊接在 PCB 印制线路板上使用。凸点和针测完成后,晶圆即进入封装测试厂 AT 厂房进行 WCSP 封装及测试,主要工艺流程如下:
(1)贴片:在自动贴膜机上在晶圆的正面贴一层保护膜(胶带),研磨过 程中保护晶圆的电路表面。该工序可能产生废胶带。
(2)背面减薄:研磨机台上,通过高速旋转的研磨轮(转速约为 2500 转每 秒)对晶圆背面进行机械研磨,将晶圆减薄到规定厚度。研磨过程中需要用超纯 水冲洗研磨硅屑和冷却研磨轮。清洗废水经回收系统回收利用后,浓水排入废水 处理站进行絮凝沉淀+中和处理。
(3)去膜:研磨完成后,去除晶圆正面的胶带。该工序可能产生废胶带。
(4)晶圆清洗:利用超纯水对晶圆表面进行冲洗,去除晶圆表面的尘埃颗 粒等杂质。清洗废水经回收系统回收利用后,浓水排入废水处理站进行絮凝沉淀 +中和处理。
(5)背面贴膜:使用背面贴膜设备在晶圆背面贴一层 BSC 膜,使晶圆背面 被胶带保护、支撑。该工序可能产生废胶带。
(6)烘干:使用背面涂层烘烤设备将膜层烘干。
(7)贴膜:使用晶圆贴片机在晶圆的背面再贴一层膜。该工序可能产生废胶带。
(8)激光打标:用激光将产品的 Lot No 刻录在产品表面(为了追踪产品的 履历)。就是在产品的表面印上去不掉的、字迹清楚的字母和标识,包括制造商的信息、国家、器件代码,生产日期等,主要是为了产品识别并跟踪,该工序将产生打印粉尘和硅粉。
(9)划片:在专门的划片机上,通过高速旋转的金刚石刀片(转速约在 50000 转每秒)将晶圆切割成符合规定尺寸的晶粒。刀片的金刚石颗粒大小只有几个微米。切割过程中利用超纯水进行刀片冷却和硅屑冲洗。
(10)激光切片:首先进行晶圆黏片,即在晶圆背面贴上水溶性保护膜然后进行切割。激光切割属非接触加工,无应力,因此切边平直整齐,无损坏;不会损伤晶圆结构,电性参数优于机械切割方式;激光可以切割任意形状,如六角形晶粒,突破了钻石刀只能以直线式加工的限制,使晶圆设计更为灵活方便。切割过程中使用超纯水进行硅屑冲洗。
(11)UV 照射:使用 UV 照射机进行 UV 照射去膜。
(12)自动检测:使用 2/3D 自动检测设备进行检测。均为物理测试。检查 产品的电气及速度特性,包括基本测试,如电气特性可靠性测试、直流电、交流 电运行测试、目视检查,以及运行速度测试等。
(13)IC 分类:使用晶粒分类设备对封装好的晶圆进行分类。
(14)终检:使用最终检测设备进行终检。
(15)包装:使用真空包装设备对封装好的芯片进行包装并入库。该工序可能产生废包材。

WCSP 工艺流程及产污环节
[来源:仪器信息网] 未经授权不得转载
版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~