







半导体&电子测试测量,投稿:kangpc@instrument.com.cn


摘要
晶圆表面缺陷检测在半导体制造中对控制产品质量起着重要作用,已成为计算机视觉领域的研究热点。然而,现有综述文献中对晶圆缺陷检测方法的归纳和总结不够透彻,缺乏对各种技术优缺点的客观分析和评价,不利于该研究领域的发展。本文系统分析了近年来国内外学者在晶圆表面缺陷检测领域的研究进展。首先,介绍了晶圆表面缺陷模式的分类及其成因。根据特征提取方法的不同,目前主流的方法分为三类:基于图像信号处理的方法、基于机器学习的方法和基于深度学习的方法。此外,还简要介绍了代表性算法的核心思想。然后,对每种方法的创新性进行了比较分析,并讨论了它们的局限性。最后,总结了当前晶圆表面缺陷检测任务中存在的问题和挑战,以及该领域未来的研究趋势以及新的研究思路。
1.引言
硅晶圆用于制造半导体芯片。所需的图案是通过光刻等工艺在晶圆上形成的,是半导体芯片制造过程中非常重要的载体。在制造过程中,由于环境和工艺参数等因素的影响,晶圆表面会产生缺陷,从而影响晶圆生产的良率。晶圆表面缺陷的准确检测,可以加速制造过程中异常故障的识别以及制造工艺的调整,提高生产效率,降低废品率。
晶圆表面缺陷的早期检测往往由经验丰富的检测人员手动进行,存在效率低、精度差、成本高、主观性强等问题,不足以满足现代工业化产品的要求。目前,基于机器视觉的缺陷检测方法[1]在晶圆检测领域已经取代了人工检测。传统的基于机器视觉的缺陷检测方法往往采用手动特征提取,效率低下。基于计算机视觉的检测方法[2]的出现,特别是卷积神经网络等神经网络的出现,解决了数据预处理、特征表示和提取以及模型学习策略的局限性。神经网络以其高效率、高精度、低成本、客观性强等特点,迅速发展,在半导体晶圆表面缺陷检测领域得到广泛应用。
近年来,随着智能终端和无线通信设施等电子集成电路的发展,以及摩尔定律的推广,在全球对芯片的需求增加的同时,光刻工艺的精度也有所提高。随着技术的进步,工艺精度已达到10纳米以下[5]。因此,对每个工艺步骤的良率提出了更高的要求,对晶圆制造中的缺陷检测技术提出了更大的挑战。
本文主要总结了晶圆表面缺陷检测算法的相关研究,包括传统的图像处理、机器学习和深度学习。根据算法的特点,对相关文献进行了总结和整理,对晶圆缺陷检测领域面临的问题和挑战进行了展望和未来发展。本文旨在帮助快速了解晶圆表面缺陷检测领域的相关方法和技能。
2. 晶圆表面缺陷模式
在实际生产中,晶圆上的缺陷种类繁多,形状不均匀,增加了晶圆缺陷检测的难度。在晶圆缺陷的类型中,无图案晶圆缺陷和图案化晶圆缺陷是晶圆缺陷的两种主要形式。这两类缺陷是芯片故障的主要原因。无图案晶圆缺陷多发生在晶圆生产的预光刻阶段,即由机器故障引起的晶圆缺陷。划痕缺陷如图1a所示,颗粒污染缺陷如图1b所示。图案化晶圆缺陷多见于晶圆生产的中间工序。曝光时间、显影时间和烘烤后时间不当会导致光刻线条出现缺陷。螺旋激励线圈和叉形电极的微纳制造过程中晶圆表面产生的缺陷如图2所示。开路缺陷如图2 a所示,短路缺陷如图2 b所示,线路污染缺陷如图2 c所示,咬合缺陷如图2d所示。
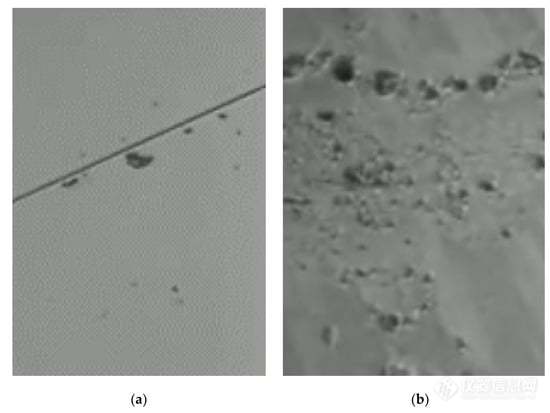
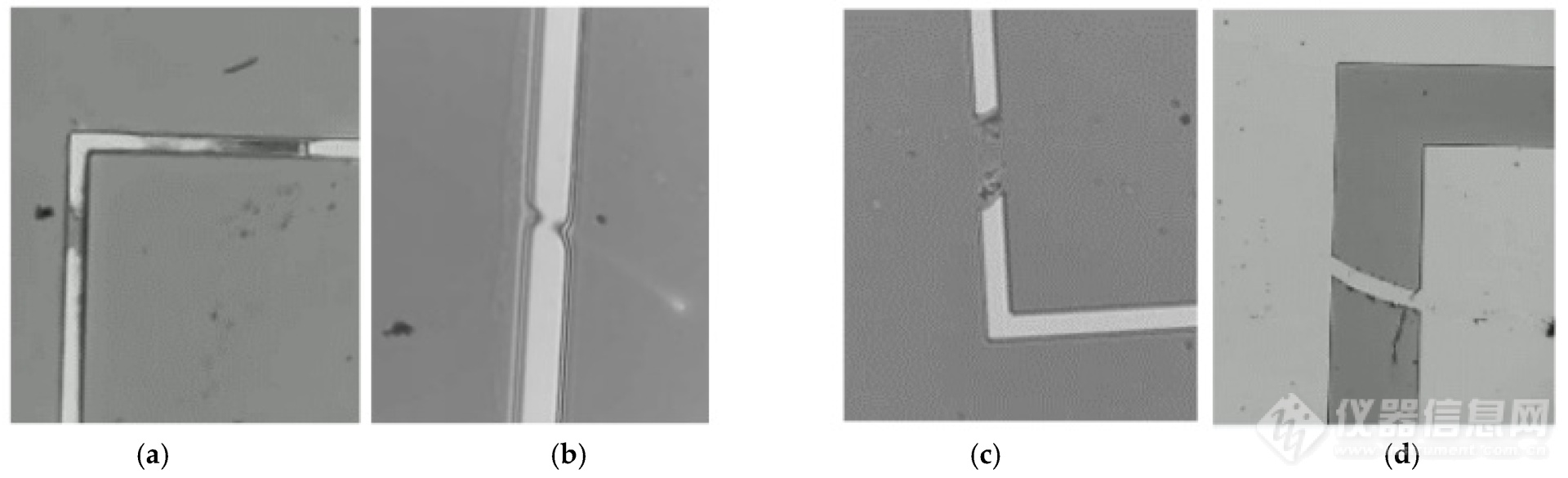
图2.(a)开路缺陷,(b)短路缺陷,(c)线路污染,以及(d)图案化晶圆缺陷图中的咬合缺陷。
由于上述晶圆缺陷的存在,在对晶圆上所有芯片进行功能完整性测试时,可能会发生芯片故障。芯片工程师用不同的颜色标记测试结果,以区分芯片的位置。在不同操作过程的影响下,晶圆上会产生相应的特定空间图案。晶圆图像数据,即晶圆图,由此生成。正如Hansen等在1997年指出的那样,缺陷芯片通常具有聚集现象或表现出一些系统模式,而这种缺陷模式通常包含有关工艺条件的必要信息。晶圆图不仅可以反映芯片的完整性,还可以准确描述缺陷数据对应的空间位置信息。晶圆图可能在整个晶圆上表现出空间依赖性,芯片工程师通常可以追踪缺陷的原因并根据缺陷类型解决问题。Mirza等将晶圆图缺陷模式分为一般类型和局部类型,即全局随机缺陷和局部缺陷。晶圆图缺陷模式图如图3所示,局部缺陷如图3 a所示,全局随机缺陷如图3b所示。全局随机缺陷是由不确定因素产生的,不确定因素是没有特定聚类现象的不可控因素,例如环境中的灰尘颗粒。只有通过长期的渐进式改进或昂贵的设备大修计划,才能减少全局随机缺陷。局部缺陷是系统固有的,在晶圆生产过程中受到可控因素的影响,如工艺参数、设备问题和操作不当。它们反复出现在晶圆上,并表现出一定程度的聚集。识别和分类局部缺陷,定位设备异常和不适当的工艺参数,对提高晶圆生产良率起着至关重要的作用。
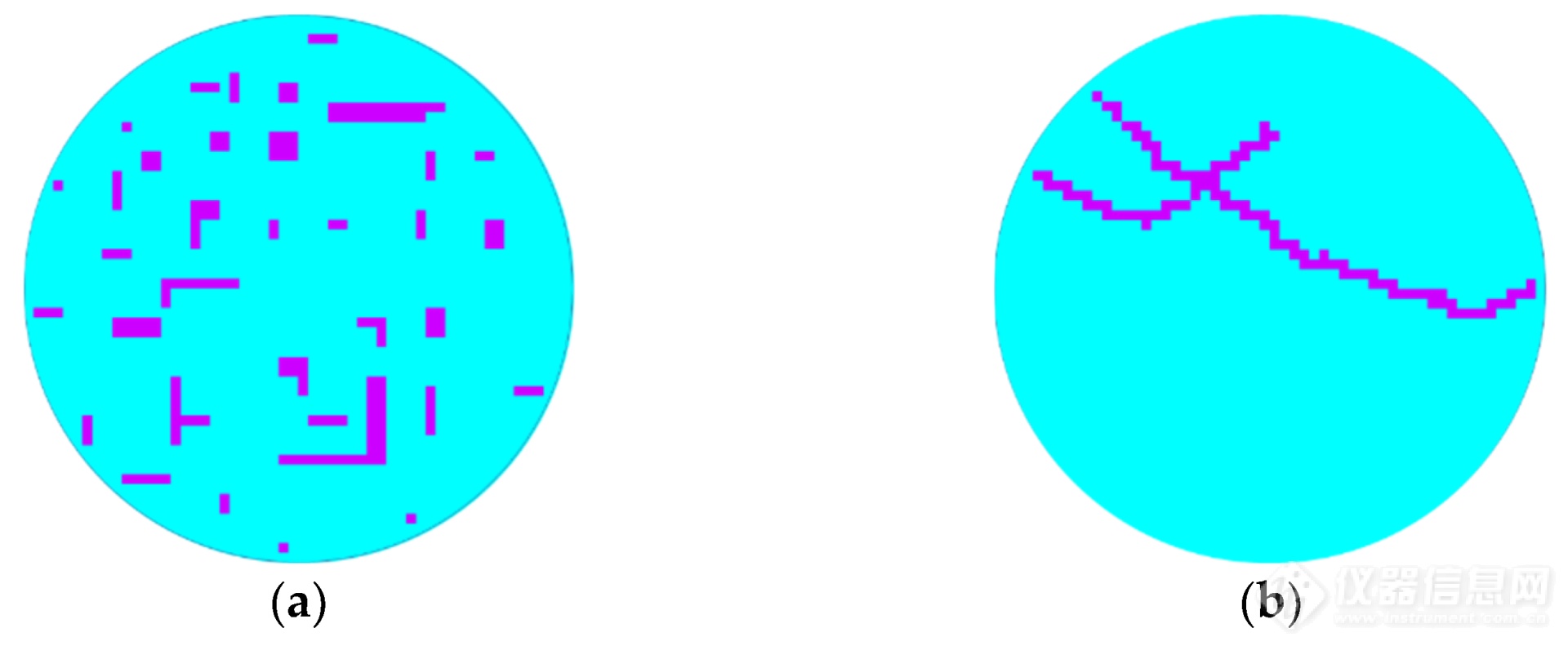
对于面积大、特征尺寸小、密度低、集成度低的晶圆图案,可以用电子显微镜观察光刻路径,并可直接进行痕量检测。随着芯片电路集成度的显著提高,进行芯片级检测变得越来越困难。这是因为随着集成度的提高,芯片上的元件变得更小、更复杂、更密集,从而导致更多的潜在缺陷。这些缺陷很难通过常规的检测方法进行检测和修复,需要更复杂、更先进的检测技术和工具。
晶圆图研究是晶圆缺陷检测的热点。天津大学刘凤珍研究了光刻设备异常引起的晶圆图缺陷。针对晶圆实际生产过程中的缺陷,我们通过设备实验对光刻胶、晶圆粉尘颗粒、晶圆环、划痕、球形、线性等缺陷进行了深入研究,旨在找到缺陷原因,提高生产率。为了确定晶圆模式失效的原因,吴明菊等人从实际制造中收集了811,457张真实晶圆图,创建了WM-811K晶圆图数据集,这是目前应用最广泛的晶圆图。半导体领域专家为该数据集中大约 20% 的晶圆图谱注释了八种缺陷模式类型。八种类型的晶圆图缺陷模式如图4所示。本综述中引用的大多数文章都基于该数据集进行了测试。
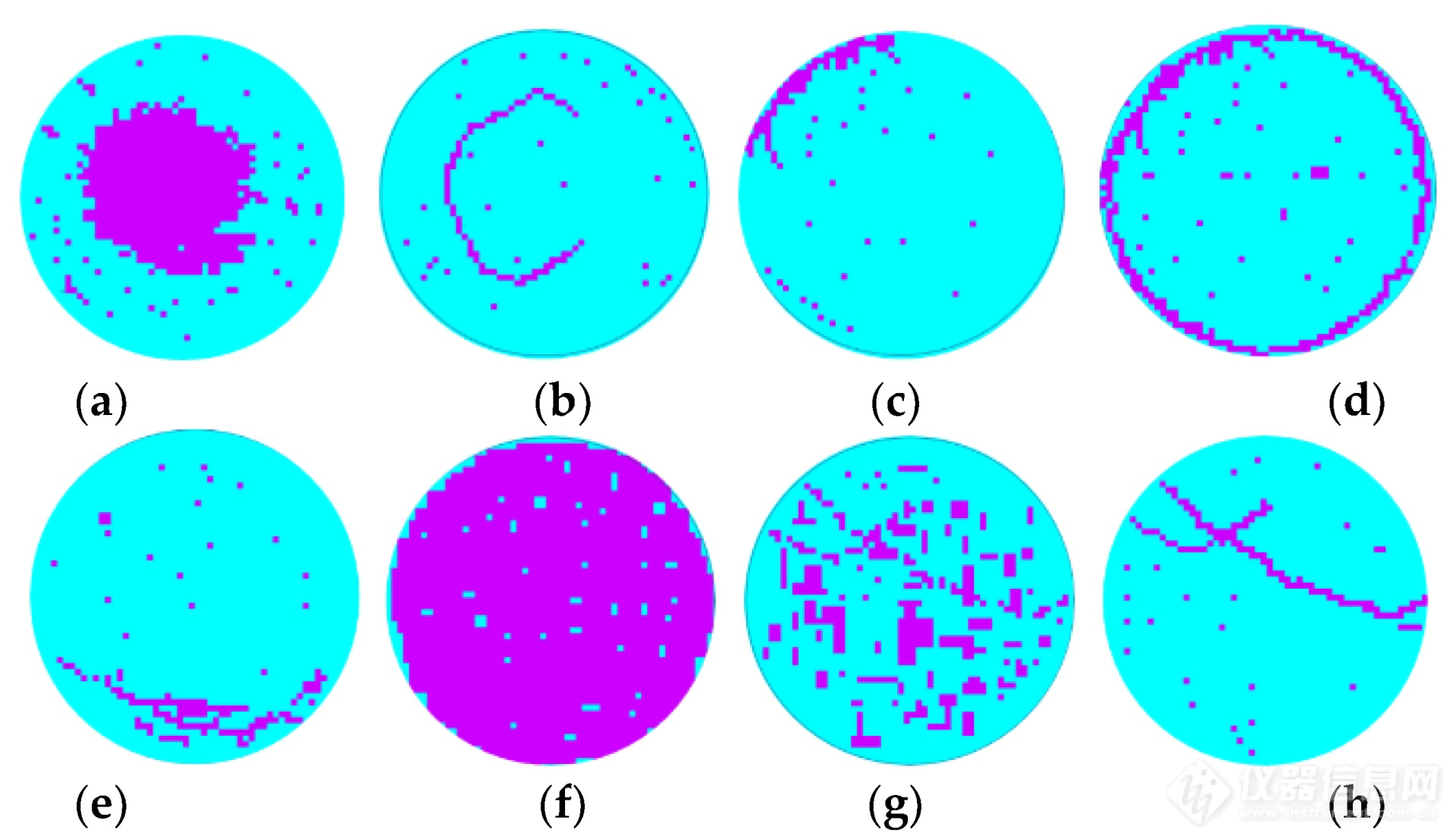
图4.八种类型的晶圆映射缺陷模式类型:(a)中心、(b)甜甜圈、(c)边缘位置、(d)边缘环、(e)局部、(f)接近满、(g)随机和(h)划痕。
3. 基于图像信号处理的晶圆表面缺陷检测
图像信号处理是将图像信号转换为数字信号,再通过计算机技术进行处理,实现图像变换、增强和检测。晶圆检测领域常用的有小波变换(WT)、空间滤波(spatial filtering)和模板匹配(template matching)。本节主要介绍这三种算法在晶圆表面缺陷检测中的应用。图像处理算法的比较如表1所示。
表 1.图像处理算法的比较。
| 模型算法 | 创新 | 局限 |
|---|---|---|
| 小波变换 | 图像可以分解为多种分辨率,并呈现为具有不同空间频率的局部子图像。防谷物。 | 阈值的选择依赖性很强,适应性差。 |
| 空间滤波 | 基于空间卷积,去除高频噪声,进行边缘增强。 | 性能取决于阈值参数。 |
| 模板匹配 | 模板匹配算法抗噪能力强,计算速度快。 | 对特征对象大小敏感。 |
3.1. 小波变换
小波变换(WT)是一种信号时频分析和处理技术。首先,通过滤波器将图像信号分解为不同的频率子带,进行小波分解;然后,通过计算小波系数的平均值、标准差或其他统计度量,分析每个系数以检测任何异常或缺陷。异常或缺陷可能表现为小波系数的突然变化或异常值。根据分析结果,使用预定义的阈值来确定信号中的缺陷和异常,并通过识别缺陷所在的时间和频率子带来确定缺陷的位置。小波分解原理图如图5所示,其中L表示低频信息,H表示高频信息。每次对图像进行分解时,图像都会分解为四个频段:LL、LH、HL 和 HH。下层分解重复上层LL带上的分解。小波变换在晶圆缺陷特征的边界处理和多尺度边缘检测中具有良好的性能。
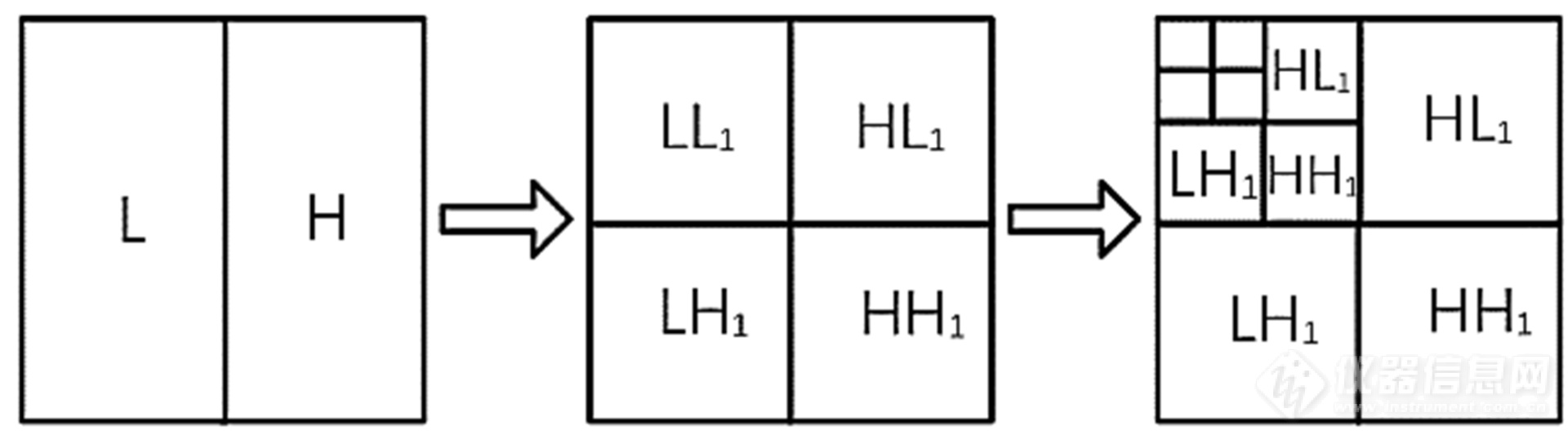
Yeh等提出了一种基于二维小波变换(2DWT)的方法,该方法通过修正小波变换模量(WTMS)计算尺度系数之间的比值,用于晶圆缺陷像素的定位。通过选择合适的小波基和支撑长度,可以使用少量测试数据实现晶圆缺陷的准确检测。图像预处理阶段耗费大量时间,严重影响检测速度。Wen-Ren Yang等提出了一种基于短时离散小波变换的晶圆微裂纹在线检测系统。无需对晶圆图像进行预处理。通过向晶圆表面发射连续脉冲激光束,通过空间探针阵列采集反射信号,并通过离散小波变换进行分析,以确定微裂纹的反射特性。在加工的情况下,也可以对微裂纹有更好的检测效果。多晶太阳能硅片表面存在大量随机晶片颗粒,导致晶圆传感图像纹理不均匀。针对这一问题,Kim Y等提出了一种基于小波变换的表面检测方法,用于检测太阳能硅片缺陷。为了更好地区分缺陷边缘和晶粒边缘,使用两个连续分解层次的小波细节子图的能量差作为权重,以增强每个分解层次中提出的判别特征。实验结果表明,该方法对指纹和污渍有较好的检测效果,但对边缘锋利的严重微裂纹缺陷无效,不能适用于所有缺陷。
3.2. 空间过滤
空间滤波是一种成熟的图像增强技术,它是通过直接对灰度值施加空间卷积来实现的。图像处理中的主要作用是图像去噪,分为平滑滤镜和锐化滤镜,广泛应用于缺陷检测领域。图6显示了图像中中值滤波器和均值滤波器在增加噪声后的去噪效果。
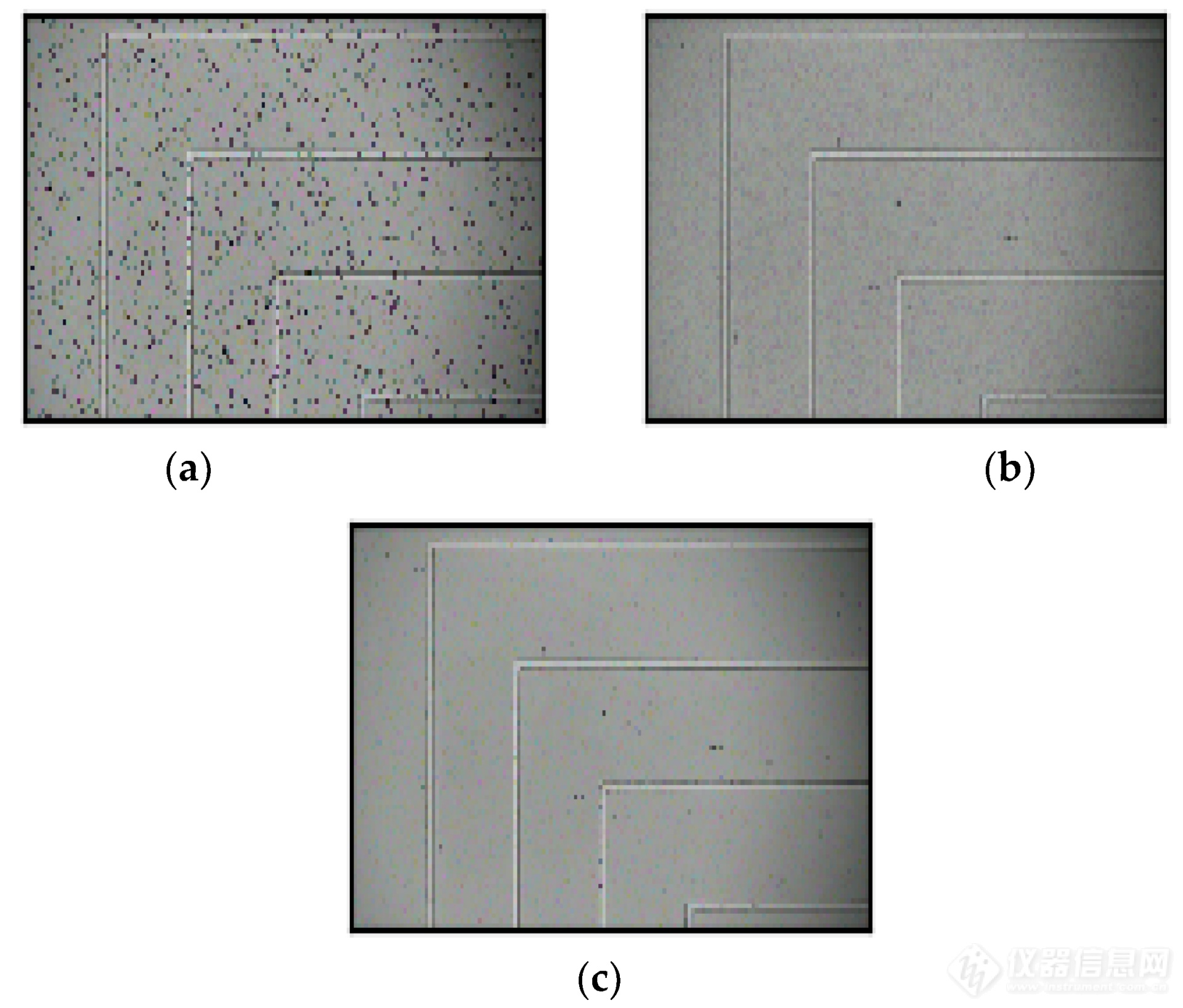
Ohshige等提出了一种基于空间频率滤波技术的表面缺陷检测系统。该方法可以有效地检测晶圆上的亚微米缺陷或异物颗粒。晶圆制造中随机缺陷的影响。C.H. Wang提出了一种基于空间滤波、熵模糊c均值和谱聚类的晶圆缺陷检测方法,该方法利用空间滤波对缺陷区域进行去噪和提取,通过熵模糊c均值和谱聚类获得缺陷区域。结合均值和谱聚类的混合算法用于缺陷分类。它解决了传统统计方法无法提取具有有意义的分类的缺陷模式的问题。针对晶圆中的成簇缺陷,Chen SH等开发了一种基于中值滤波和聚类方法的软件工具,所提算法有效地检测了缺陷成簇。通常,空间过滤器的性能与参数高度相关,并且通常很难选择其值。
3.3. 模板匹配
模板匹配检测是通过计算模板图像与被测图像之间的相似度来实现的,以检测被测图像与模板图像之间的差异区域。
Han H等从晶圆图像本身获取的模板混入晶圆制造工艺的设计布局方案中,利用物理空间与像素空间的映射,设计了一种结合现有圆模板匹配检测新方法的晶圆图像检测技术。刘希峰结合SURF图像配准算法,实现了测试晶圆与标准晶圆图案的空间定位匹配。测试图像与标准图像之间的特征点匹配结果如图7所示。将模式识别的轮廓提取技术应用于晶圆缺陷检测。Khalaj等提出了一种新技术,该技术使用高分辨率光谱估计算法提取晶圆缺陷特征并将其与实际图像进行比较,以检测周期性2D信号或图像中不规则和缺陷的位置。
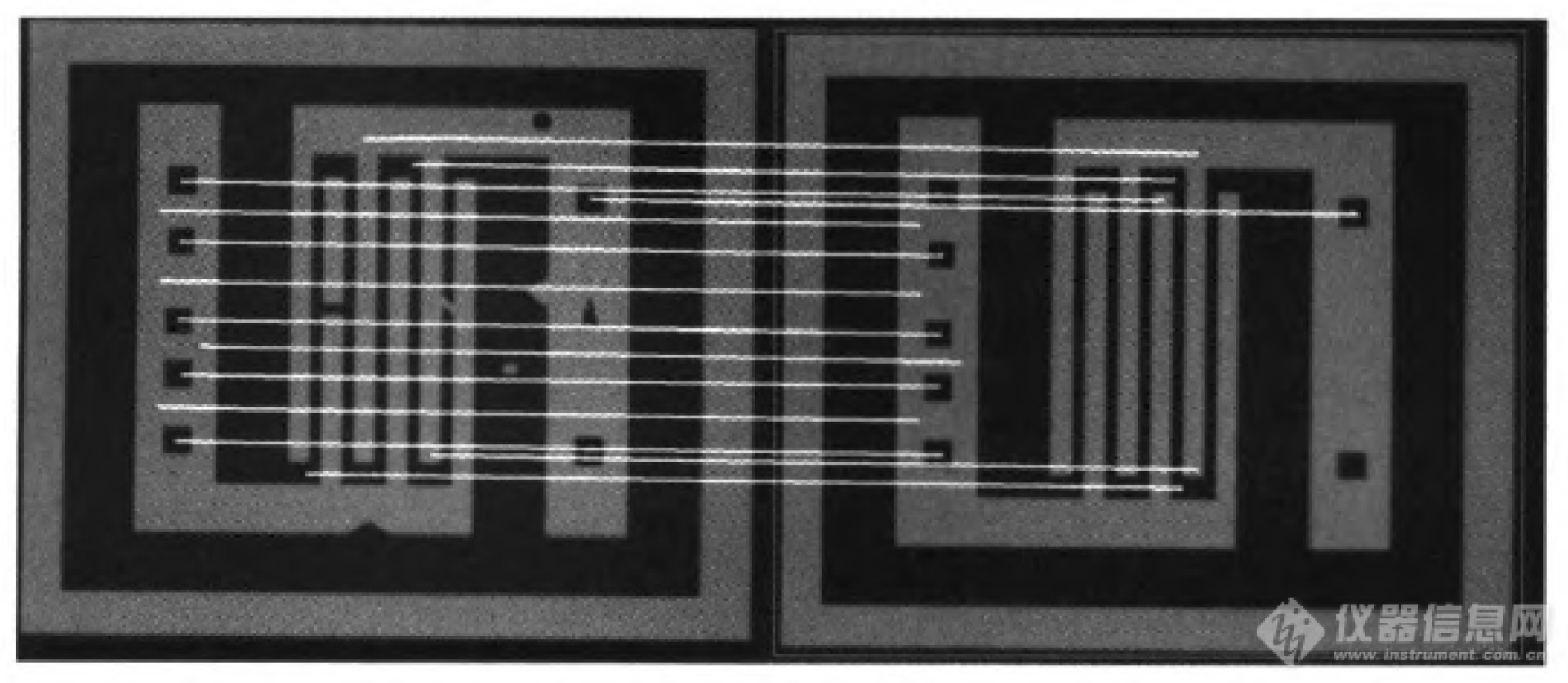
[来源:仪器信息网译] 未经授权不得转载
 晶圆表面缺陷检测方法综述【下】
晶圆表面缺陷检测方法综述【下】版权与免责声明:
① 凡本网注明"来源:仪器信息网"的所有作品,版权均属于仪器信息网,未经本网授权不得转载、摘编或利用其它方式使用。已获本网授权的作品,应在授权范围内使用,并注明"来源:仪器信息网"。违者本网将追究相关法律责任。
② 本网凡注明"来源:xxx(非本网)"的作品,均转载自其它媒体,转载目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,且不承担此类作品侵权行为的直接责任及连带责任。如其他媒体、网站或个人从本网下载使用,必须保留本网注明的"稿件来源",并自负版权等法律责任。
③ 如涉及作品内容、版权等问题,请在作品发表之日起两周内与本网联系,否则视为默认仪器信息网有权转载。
![]() 谢谢您的赞赏,您的鼓励是我前进的动力~
谢谢您的赞赏,您的鼓励是我前进的动力~
打赏失败了~
评论成功+4积分
评论成功,积分获取达到限制
![]() 投票成功~
投票成功~
投票失败了~