半导体封装材料的性能评估和热失效分析
前言
芯片封装的主要目的是为了保护芯片,使芯片免受苛刻环境和机械的影响,并让芯片电极和外界电路实现连通,如此才能实现其预先设计的功能。常用的一种封装技术是包封或密封,通常采用低温的聚合物来实现。例如,导电环氧银胶用于芯片和基板的粘接,环氧塑封料用于芯片的模塑封,以及底部填充胶用于倒装焊芯片与基板间的填充等。主要的封装材料、工艺方法及特性如图1所示。
包封必须满足一定的机械、热以及化学特性要求,不然直接影响封装效果以及整个器件的可靠性。流动和粘附性是任何包封材料都必须优化实现的两个主要物理特性。在特定温度范围内的热膨胀系数(CTE)、超出可靠性测试范围(-65℃至150℃)的玻璃化转变温度(Tg)对封装的牢固性至关重要。对于包封,以下要求都是必须的:包封材料的CTE和焊料的CTE比较接近以确保两者之间的低应力;在可靠性测试中,玻璃转化温度(Tg)能保证尺寸的稳定性;在热循环中,弹性模量不会导致大的应力;断裂伸长率大于1%;封装材料必须有低的吸湿性。但是,这些特性在某种类型的环氧树脂里并不同时具备。因此,包封用的环氧树脂是多种环氧的混合物。表1列出了倒装焊底部填充胶的一些重要的特性。随着对半导体器件的性能要求越来越高,对封装材料的要求同步提高,尤其是在湿气的环境下,性能评估和热失效分析更是至关重要,而这些都可以通过热分析技术给予准确测量,并可进一步用于工艺的CAE模拟仿真,帮助准确评估封装质量的优劣与否。
表1 倒装焊中底部填充胶的性能要求[1]


图1. 主要封装材料、工艺方法及特性[2]
热性能检测
梅特勒托利多全套热分析技术为半导体封装材料的性能评估和热失效分析提供全面、创新的解决方案。差示扫描量热仪DSC可以精准评估封装材料的Tg、固化度、熔点和Cp,并且结合行业内具有优势的动力学模块(非模型动力学MFK)可以高精准评估环氧胶的固化反应速率,从而为Moldex 3D模拟环氧塑封料、底部填充胶的流动特性提供可靠的数据。如图2所示,在非模型动力学的应用下,环氧胶在180℃下所预测的固化速率与实际测试曲线所表现出的固化行为具有非常高的一致性。热重TGA或同步热分析仪TGA/DSC可以准确测量封装材料的热分解温度,如失重1%时的温度,以及应用热分解动力学可以评估焊料在一定温度下的焊接时间。热机械分析仪TMA可以精准测量封装材料的热膨胀、固化时的热收缩、以及CTE和Tg,动态机械分析仪DMA提供封装材料准确的弹性模量、剪切模量、泊松比、断裂伸长率等力学数据,进一步可为Moldex 3D模拟芯片封装材料的翘曲和收缩提供可靠数据来源。

图2. DSC结合非模型动力学评估环氧胶的固化反应速率
检测难点
1、 凝胶时间
凝胶时间是Moldex 3D模拟环氧塑封料、底部填充胶流动特性的非常重要的数据来源之一。目前,行业内有多种测试凝胶时间的方法和设备。比如利用拉丝原理的凝胶时间测试仪,另有国家标准GB 12007.7-89环氧树脂凝胶时间测定方法[3],即利用标准柱塞在环氧树脂固化体系中往复运动受阻达到一个值而指示凝胶时间。但是,其对柱塞的形状和浮力要求较高,测试样品量也很大,仅适用于在试验温度下凝胶时间不小于5 min的环氧树脂固化体系,并且不适用于低于室温的树脂、高粘度树脂和有填料的体系。由此可见,现有测试方法都存在测试误差、硬件缺陷和测试范围有限等问题。
梅特勒托利多创新性TMA/SDTA2+的DLTMA(动态载荷TMA)模式结合独家的负力技术可以准确测定凝胶时间。在常规TMA测试中,探针上施加的是恒定力,而在DLTMA模式中,探针上施加的是周期性力。如图3右上角插图所示,探针上施加的力随时间的变化关系,力在0.05N与-0.05N之间周期性变化,这里尤为关键的一点是,测试凝胶时间必须要使用负力,即不仅需要探针往下压,还需要探针能够自动向上抬起。图3所示案例为测试导电环氧银胶的凝胶时间,样品置于40μl铝坩埚内并事先固定在TMA石英支架平台上,采用直径为1.1 mm的平探针在恒定160℃条件下施加正负力交替变换测试。在未发生凝胶固化之前,探针不会被样品粘住,负力技术可使探针自由下压和抬起,测试的位移曲线表现出较大的位移变化。当发生交联固化,所施加的负力不足以将探针从样品中抬起,位移振幅突然减小为0,曲线成为一条直线。通过分析位移突变过程中的外推起始点即可得到凝胶时间。此外,固化后的环氧银胶片,可通过常规的TMA测试获得Tg以及玻璃化转变前后的CTE,如图3下方曲线所示。

图3. 上图:TMA/SDTA2+的DLTMA模式结合负力技术准确测定凝胶时间. 下图:固化导电环氧银胶片的CTE和Tg测试.
2、 弯曲弹性模量
在热循环过程中,弹性模量不会导致过大的应力。封装材料在不同温度下的弹性模量可通过DMA直接测得。日本工业标准JIS C6481 5.17.2里要求使用弯曲模式对厚度小于0.5mm、跨距小于4mm、宽度为10mm的封装基板进行弯曲弹性模量测试。从DMA测试技巧角度来讲,如此小尺寸的样品应首选拉伸模式测试。弯曲模式在DMA中一共有三种,即三点弯曲、单悬臂和双悬臂,从样品的刚度及夹具的刚度和尺寸考虑,三点弯曲和双悬臂并不适合此类样品的测试。因此,单悬臂成为唯一的可能性,但考虑到单悬臂夹具尺寸和跨距小于4mm的要求,市面上大部分DMA难以满足此类测试。梅特勒托利多创新性DMA1另标配了单悬臂扩展夹具,可方便夹持小尺寸样品并能实现最小跨距为1mm的测试。图4为对厚度为40μm的基板分别进行x轴和y轴方向上的单悬臂测试,在跨距3.5mm、20Hz的频率下以10K/min的升温速率从25℃加热至350℃。从tan delta的出峰情况可以判断基板的Tg在241℃左右,以及在室温下的弯曲弹性模量高达12-13GPa。
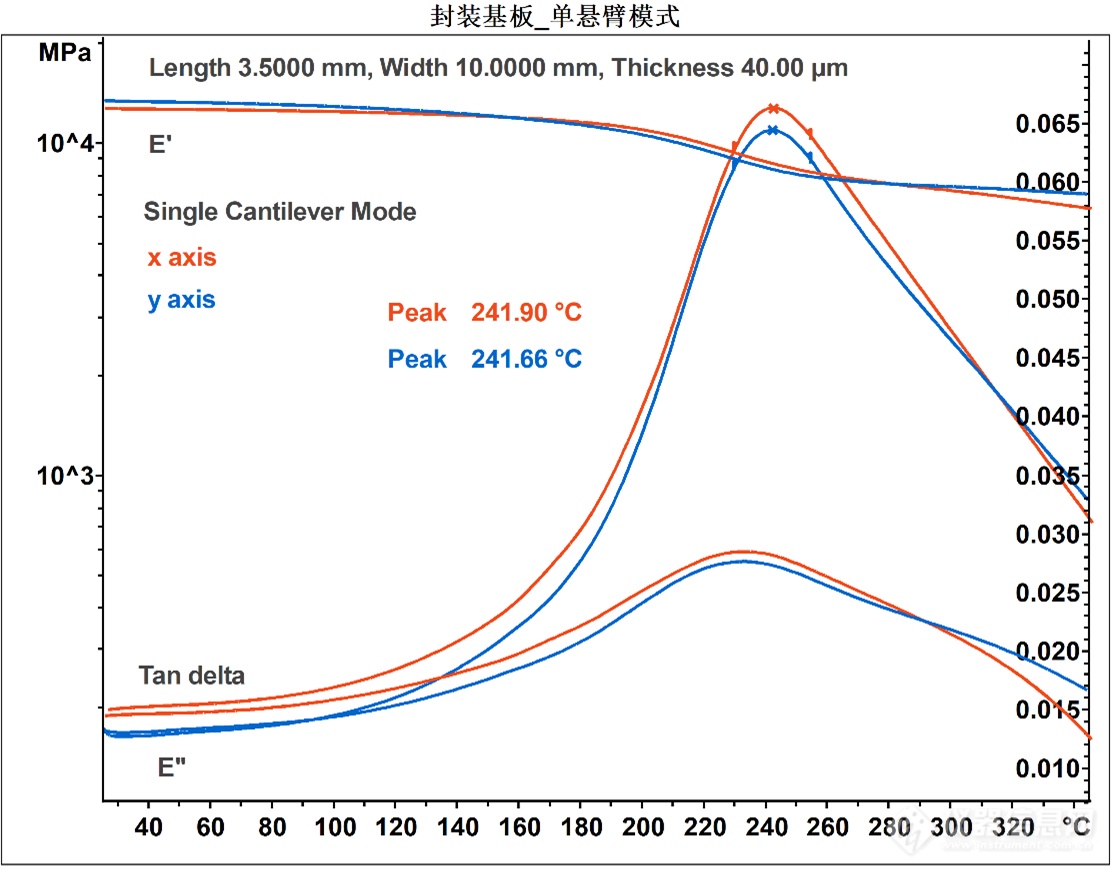
图4. DMA1单悬臂扩展夹具测试封装基板的弯曲弹性模量.
3、 湿气对封装材料的影响
湿气腐蚀是IC封装失效的主要原因,其降低了器件的性能和可靠性。保存在干燥环境下的封装环氧胶,完全固化后在高温和高湿气环境下也会吸湿发生水解,降低封装体的机械性能,无法有效保护内部的芯片。此外,焊球和底部填充环氧胶之间的粘附强度在湿气环境中放置一段时间后也会遭受破坏。水汽的吸收导致环氧胶的膨胀,并引起湿应力,这是引线连接失效的主要因素。通过湿热试验可以对封装材料的抗湿热老化性能进行系统的评估,进而对其进行改善,提升整体性能。通常是采用湿热老化箱进行处理,然后实施各项性能的评估。因此,亟需提供一种能够提高封装材料湿热老化测试效率的方法。梅特勒托利多TMA/SDTA2+和湿度发生器的联用方案,以及DMA1和湿度发生器的联用方案可以实现双85(85℃、85%RH)和60℃、90%RH的技术参数,这也是行业内此类湿度联用很难达到的技术指标。因此,可以原位在线环测封装材料在湿热条件下的尺寸稳定性和力学性能。
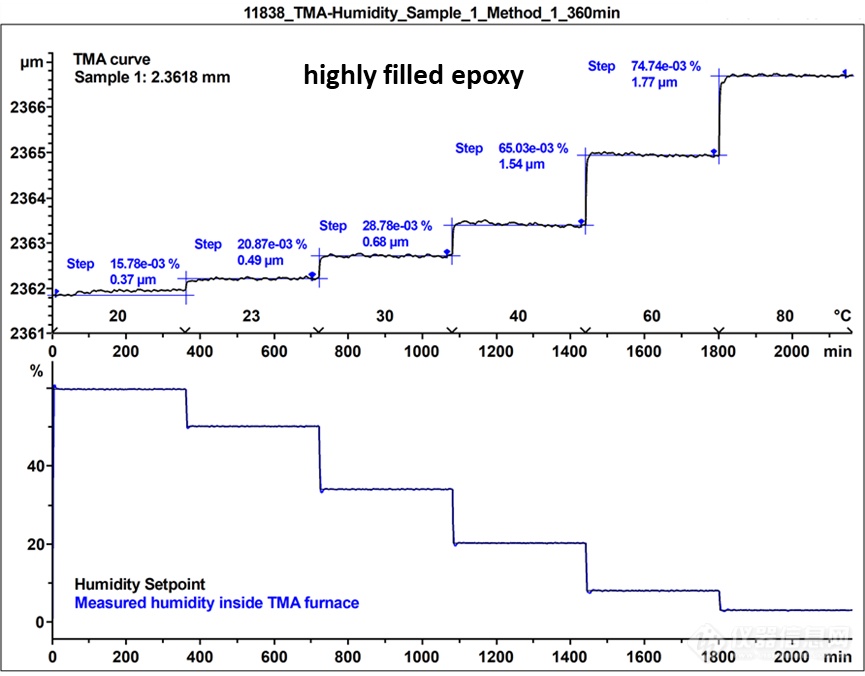
图5. TMA/SDTA2+-湿度联用方案测试高填充环氧的尺寸变化.
图5显示了TMA-湿度联用方案在不同湿热程序下高填充环氧的尺寸变化。湿热程序分别为20℃、60%RH、约350min,23℃、50%RH、约350min,30℃、30%RH、约350min,40℃、20%RH、约350min,60℃、10%RH、约350min,80℃、5%RH、约350min。可以看出,在60%的高湿环境下高填充环氧在350min内膨胀约0.016%,后续再降低湿度并升高温度,样品主要在温度的作用下发生较大的热膨胀。
图6为DMA-湿度联用方案在双85的条件下评估PCB的机械性能的稳定性,测试时间为7天。可以看出,PCB在高湿热的环境下弹性模量有近似6%的变化,这与PCB的树脂材料发生吸湿后膨胀并引起湿应力是密不可分的,并且存在导致器件失效的风险。

图6. DMA1-湿度联用方案测试PCB的弹性模量.
4、 化学品质量对于封装结果的影响
封装过程中会使用到各类的湿电子化学品,尤其是晶圆级封装等先进封装的工艺流程,对于清洗液、蚀刻液等材料的质量管控可以类比晶圆制造过程中的要求,同时针对不同工艺段的化学品浓度等配比都有所不同,因此如何控制使用的电子化学品质量对于封装工艺的效能有着重要的意义。
下表展示了部分涉及到的化学品浓度检测的滴定检测方案,常规的酸碱滴定、氧化还原滴定可以基本满足对于单一品类化学品浓度的检测需求。
指标 | 电极 | 滴定剂 | 样品量 |
85%H3PO4 | 酸碱玻璃电极 | 1mol/L NaOH | 0.5~1g |
96%H2SO4 | 酸碱玻璃电极 | 1mol/L NaOH | 0.5~1g |
70%HNO3 | 酸碱玻璃电极 | 1mol/L NaOH | 0.5~1g |
36%HCl | 酸碱玻璃电极 | 1mol/L NaOH | 0.5~1g |
49%HF | 特殊耐HF酸碱电极 | 1mol/L NaOH | 0.3~0.4g |
DHF(100:1) | 特殊耐HF酸碱电极 | 1mol/L NaOH | 20-30g |
29%氨水 | 酸碱玻璃电极 | 1mol/L NaOH | 0.9~1.2g |
ECP(acidity) | 酸碱玻璃电极 | 1mol/L NaOH | ≈8g |
29%NH4OH | 酸碱玻璃电极 | 1mol/L HCl | 0.5~1g |
CTS-100清洗液 | 酸碱玻璃电极 | 1mol/L NaOH | ≈1g |
表1. 部分化学品检测方法列表
另一方面,对于刻蚀液等品类,常常会用到混酸等多种物质混配而成的化学品,以起到综合的反应效果,如何对于此类复杂的体系浓度进行检测,成为实际生产过程中比较大的挑战。
梅特勒托利多自动电位滴定仪,针对不同的混合液制订不同的检测方案,如铝刻蚀液的硝酸/磷酸/醋酸混合液,在乙醇和丙二醇混合溶剂的作用下,采用非水酸碱电极针对不同酸液pKa的不同进行检测,得到以下图谱,一次滴定即可测定三种组分的含量。
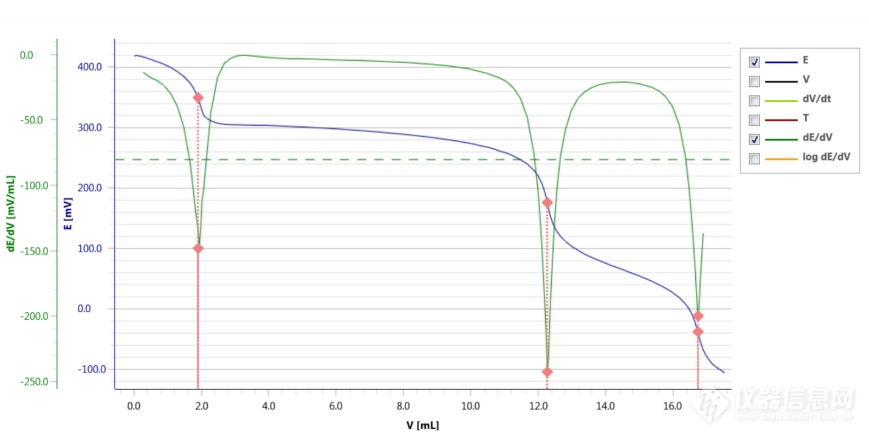
图7. 一种铝刻蚀液滴定曲线
结论
梅特勒托利多一直致力于帮助用户提高研发效率和质量控制,我们为半导体封装整个产业链提供完整专业的产品、应用解决方案和可靠服务。梅特勒托利多在半导体封装行业积累了大量经验和数据,希望我们的解决方案给半导体封装材料性能评估的工作者带来帮助。
参考文献
[1] Rao R. Tummala. 微系统封装基础. 15. 密封与包封基础 page 544-545.
[2] Rao R. Tummala. 微系统封装基础. 18. 封装材料与工艺基础 page 641.
[3] GB12007.7-89:环氧树脂凝胶时间测定方法.
(梅特勒-托利多 供稿)
更多![]()
新品上市_X'TRA Companion 高阶常规分析型台式XRD
新品
2023.08.23
助力边疆少年 共铸生态文明梦!
厂商
2024.03.29
新品发布-蔡司辐射损伤智能分析方案
新品
2024.04.24
邀请函 | 欧波同材料显微分析技术论坛
厂商
2024.05.29