徕卡DM8000M,DM12000M 半导体尺寸外观检测方案
2024/05/16 16:48
阅读:23
分享:
![]() 免费下载
免费下载
方案摘要:
产品配置单:
德国徕卡 Leica 8寸晶圆半导体检测系统DM8000M
型号: DM8000M
产地: 德国
品牌: 徕卡
¥28万 - 38万
参考报价
联系电话
方案详情:
徕卡DM8000M,DM12000M 半导体尺寸外观检测方案

利用光学显微镜揭示关键细节,在电子工业中高效可靠地进行半导体质量控制
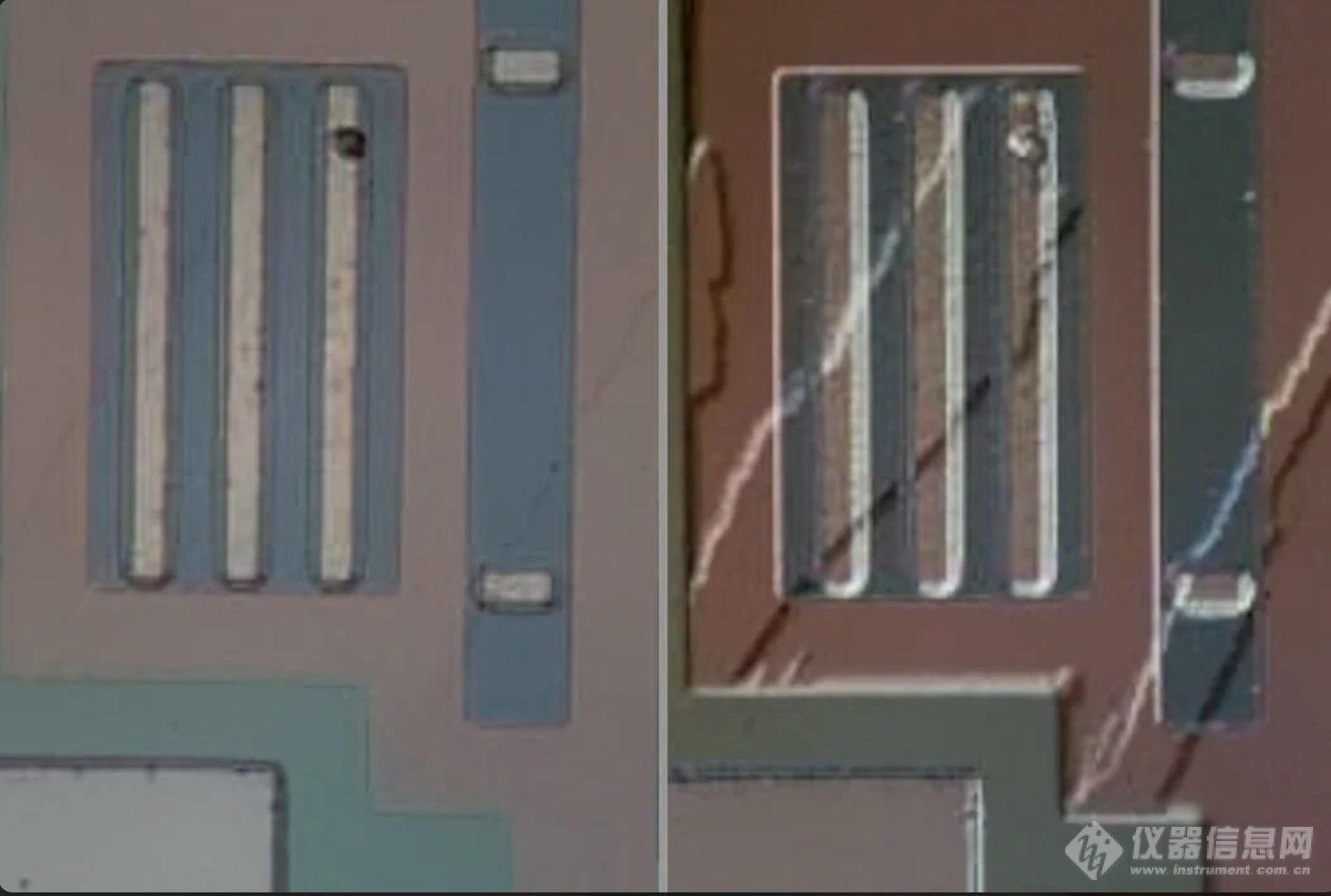
已刻蚀的晶圆和集成电路(IC)在生产过程中的半导体检测对于识别和减少缺陷非常重要。为了提高早期生产阶段的质量控制效率,确保集成电路芯片性能可靠,显微镜解决方案应结合不同的观察方法,提供有关不同缺陷的完整而准确的信息。这里介绍的观察方法包括明场、暗场、偏光、DIC、紫外、斜照明和红外。它们被集成到显微镜中,用于晶圆和集成电路的检测和研发。
半导体制造业如何从显微镜中获益
显微镜解决方案在半导体制造业的高效可靠检测、质量控制 (QC)、故障分析 (FA) 和研发 (R&D) 中发挥着重要作用。
在半导体制造过程中,不同步骤可能会出现多种类型的缺陷,从而影响设备的正常运行。这些缺陷越早发现越好。这些缺陷可能是由于随机分布在晶片上的灰尘颗粒(随机缺陷),也可能是由于加工条件(例如在刻蚀过程中)造成的涂层和光刻胶的划痕、脱落和残留,并且会出现在晶片的特定区域。由于其尺寸较小,显微镜是识别此类缺陷的首选工具。
尤其是光学显微镜(OM)与电子显微镜(EM)等速度较慢、成本较高的显微镜相比,具有许多优势。由于光学显微镜的多功能性和易用性,它通常用于定性和定量研究裸晶圆和刻蚀/加工晶圆上的缺陷,也用于集成电路(IC)的组装和封装过程。
不同的光学显微观察方法,如明场 (BF)、暗场 (DF)、微分干涉对比 (DIC)、偏光 (POL)、紫外 (UV)、斜照明和红外线 (IR) 透射光 [1-4] 对于在晶圆和集成电路芯片检测过程中快速、准确地检测缺陷至关重要。
检查过程中需要克服的挑战
随着刻蚀结构和微电子元件尺寸的迅速缩小,生产中对使用较大晶圆的需求不断增加。由于尺寸越来越小,使用光学显微镜观察半导体材料、加工晶圆和集成电路芯片的表面结构和缺陷有时变得非常困难。为了提高检测效率,用户需要在低倍镜下快速扫描晶圆或材料的大面积区域,以确定感兴趣的区域(参见图 1),然后在高倍镜下准确观察非常精细的细节、结构和缺陷。
传统光学显微镜可能难以观察到加工晶片上的某些缺陷,如灰尘、划痕、脱落或涂层和光刻胶残留。在这种情况下,需要将样品转移到电子显微镜或其他仪器上。不过,下文将举例说明不同的光学显微镜观察方法如何使半导体和晶片检测变得高效。
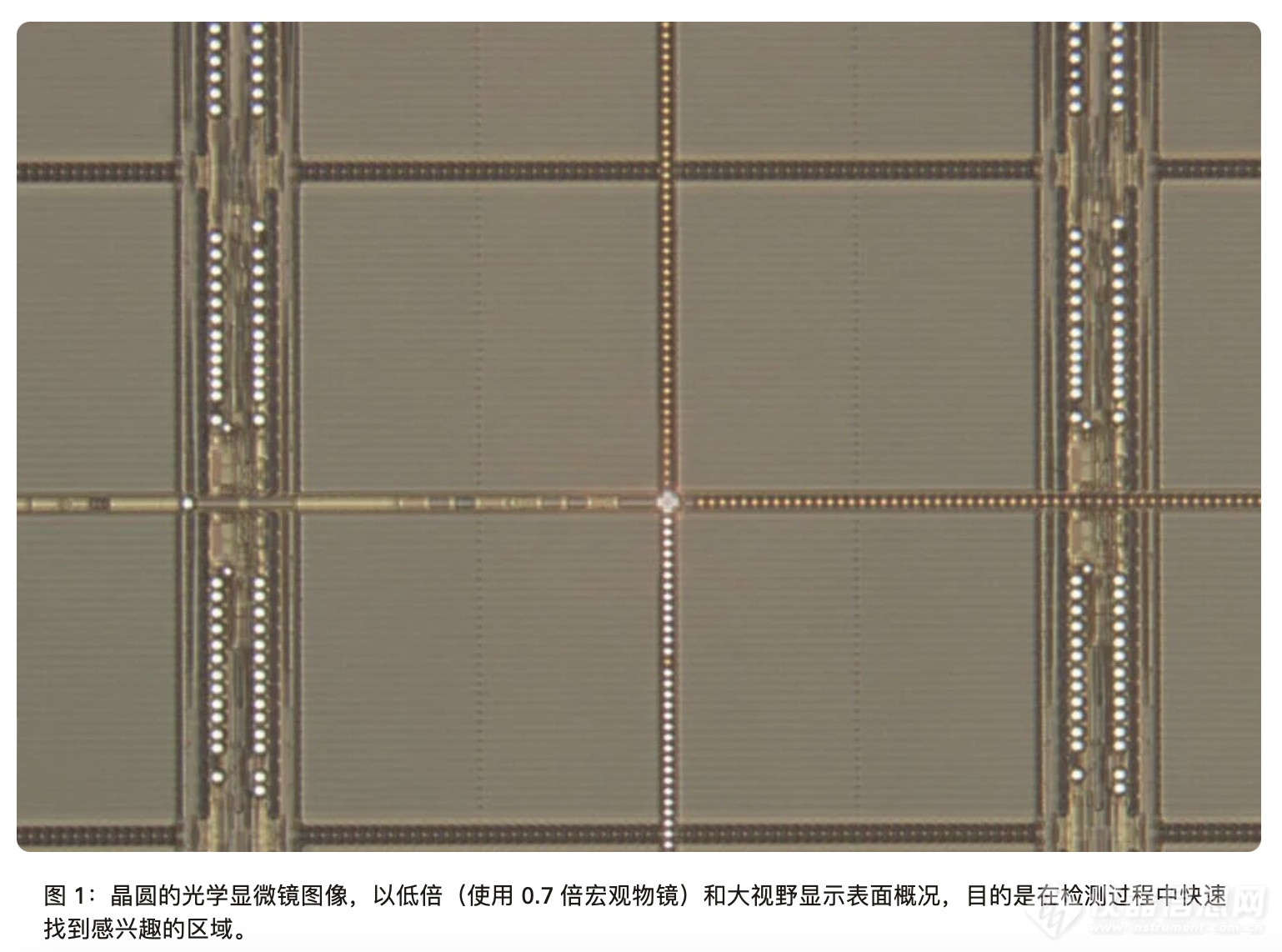
显微镜观察方法
下面给出了用入射光对不透明材料(可见光谱)(如半导体)成像的 OM 观察方法 BF(明场)、DF(暗场)、DIC(微分干涉对比)、POL(偏光)、UV(紫外)、斜照和 IR TL(红外透射光) [1-4] 的基本背景信息。有关这些观察方法的更多详情,请参阅参考文献 1 至 4。
使用常见的 BF 照明时,要看清某些晶片缺陷可能很困难。因此,可能需要使用其他观察方法,如 DF、DIC、POL、UV 和斜照 [1-4]等,才能清楚地看到这些缺陷,从而不必将样品转移到电子显微镜或其他仪器上。
BF 照明 [1-3] 是检测缺陷最常用的方法。在 BF 成像过程中,可观察到从半导体或晶片样品表面直接反射的入射白光。平整光亮的表面会将大量光线反射回目镜或相机,因此在观察时样品会显得明亮。相比之下,带有孔洞和其他特征的图案表面会散射光线,因此样品看起来更暗,对比度更高。但是,对于反射样品,一些结构仍然会被明亮的照明 "淹没",因此不容易看到。使用 BF 照明拍摄的晶片图像示例如图 2 所示。

图 2:在 BF 照明下以更高倍率(20 倍平面 fluotar 或 150 倍 pl apo 物镜)拍摄的晶圆光学显微镜图像,以查找缺陷、颗粒和污染(与图 3-5 进行比较): A) 图 1 中整个正方形的中心(20x);B) 有规律的方块凸起(150x);C) 处理过的晶圆(150x);D)已刻蚀的集成电路(20x);E) 有污染的已刻蚀的晶圆圆。
DF 照明也比较常见 [1-3]。在 DF 成像过程中,大部分入射白光不会反射回物镜,而是会避开物镜,因为光线会以相对于垂直方向的高角度撞击样品表面。因此不存在强光 "淹没 "样品结构的风险。只有一些从非平坦表面特征散射的光线才能真正到达目镜或相机。表面的平整区域看起来较暗,而非平整的图案区域,即使有非常小的特征,如气孔、凸起、划痕和灰尘颗粒,看起来也较亮。使用 DF 照明拍摄的晶片图像示例如图 3 所示。
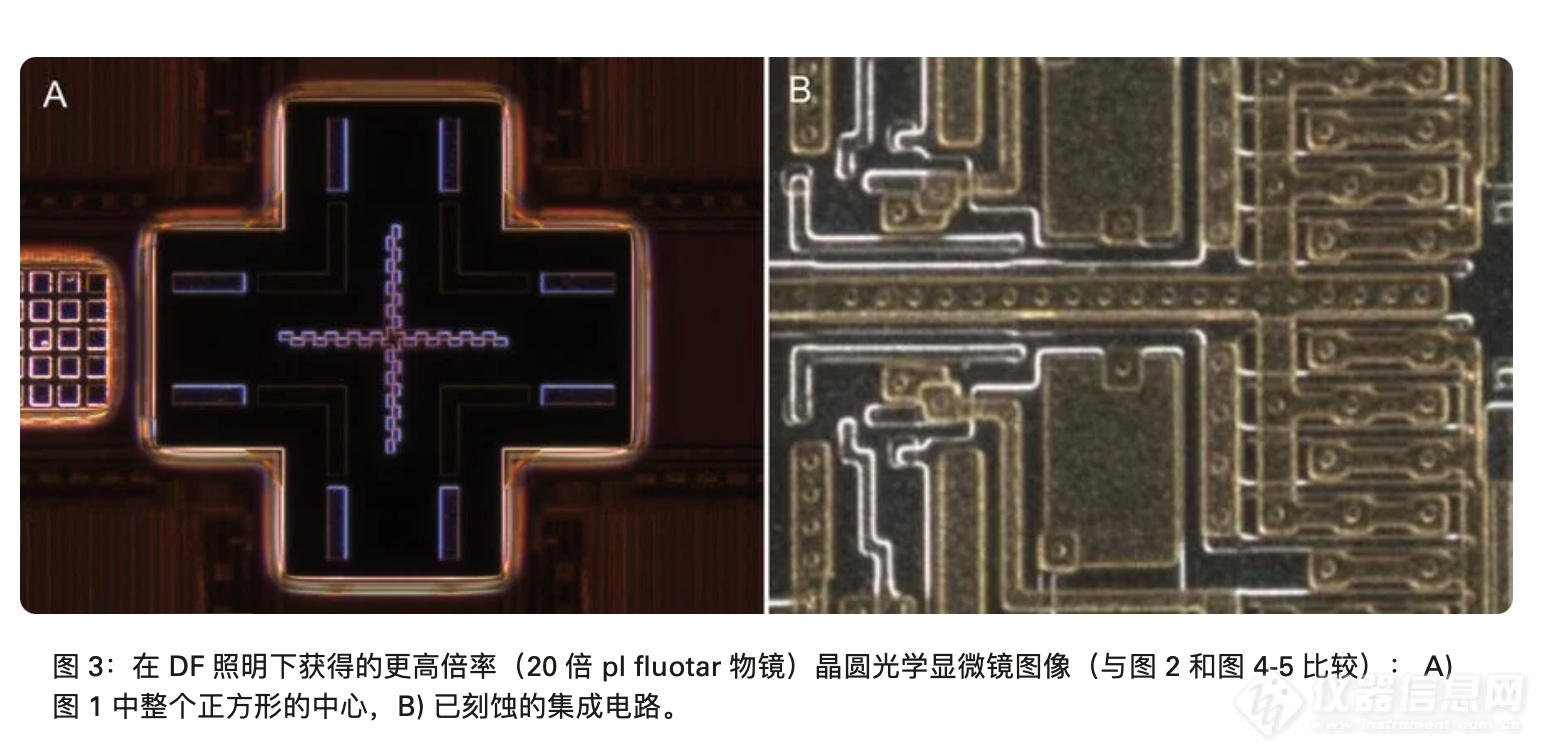
图 3:在 DF 照明下获得的更高倍率(20 倍 pl fluotar 物镜)晶圆光学显微镜图像(与图 2 和图 4-5 比较): A) 图 1 中整个正方形的中心,B) 已刻蚀的集成电路。
BF 和 DF 都可用于获取有关横向尺寸的信息,但很少或根本无法获取有关纵向尺寸的信息。
DIC 成像比 BF 或 DF 都不常用 [1-3]。它使用棱镜将偏振入射白光分离成两束光,这两束光从样品表面反射,然后重新穿过棱镜,再汇合在一起。重新汇合的光束发生干涉,形成椭圆偏振光,然后通过检偏器。通过这种干涉,可以观察到样品刻蚀过的表面和结构的微小高度变化。使用 DIC 照明拍摄的晶片图像示例如图 4 所示。
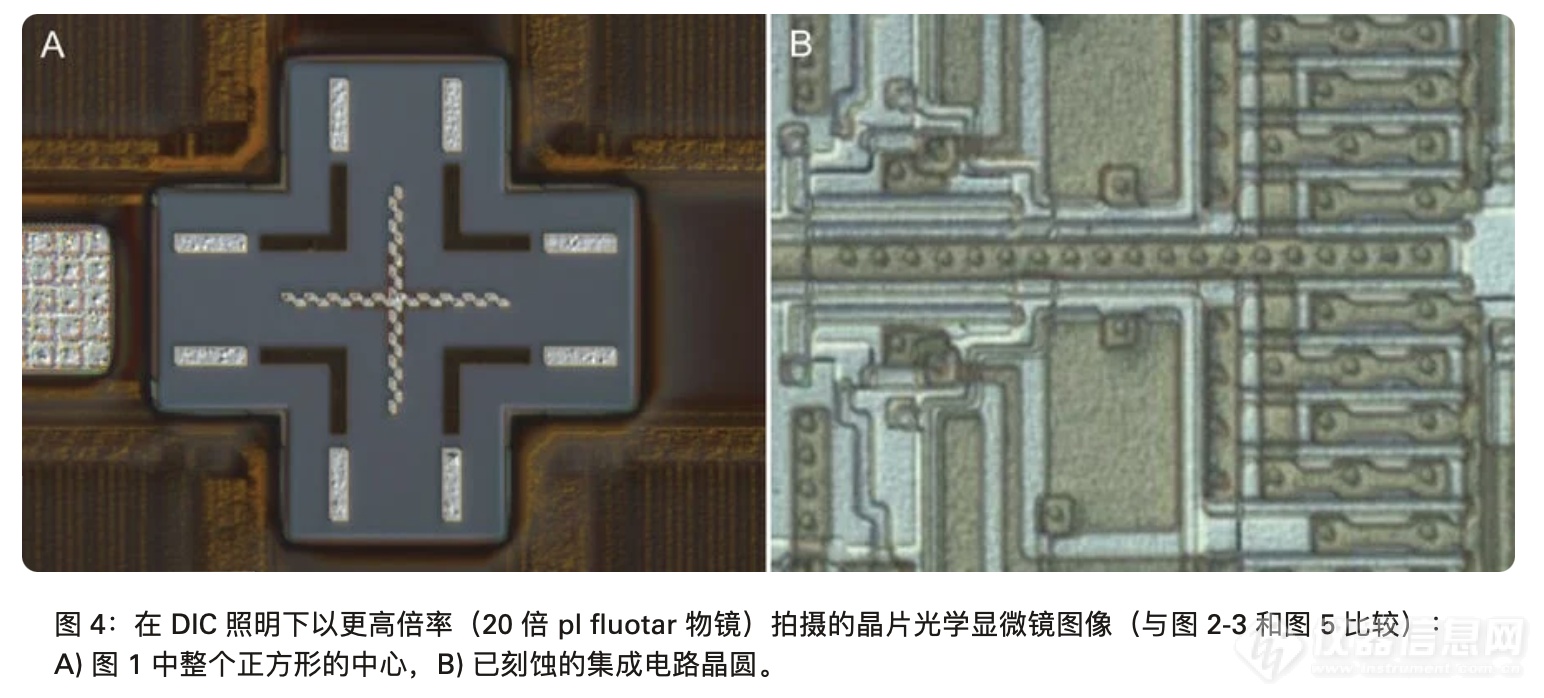
图 4:在 DIC 照明下以更高倍率(20 倍 pl fluotar 物镜)拍摄的晶片光学显微镜图像(与图 2-3 和图 5 比较): A) 图 1 中整个正方形的中心,B) 已刻蚀的集成电路晶圆。
与 BF、DF 或 DIC 相比,POL 成像更较少使用 [1-4]。POL 成像使用 2 个偏振器来提供光学各向异性材料的信息。对比度来自平面偏振光与双折射样品(即双折射样品)的相互作用,产生异相光波。然后,这些光波通过第二偏振器(也称为起偏器)重新组合,从而提供有关样品结构和成分的信息。
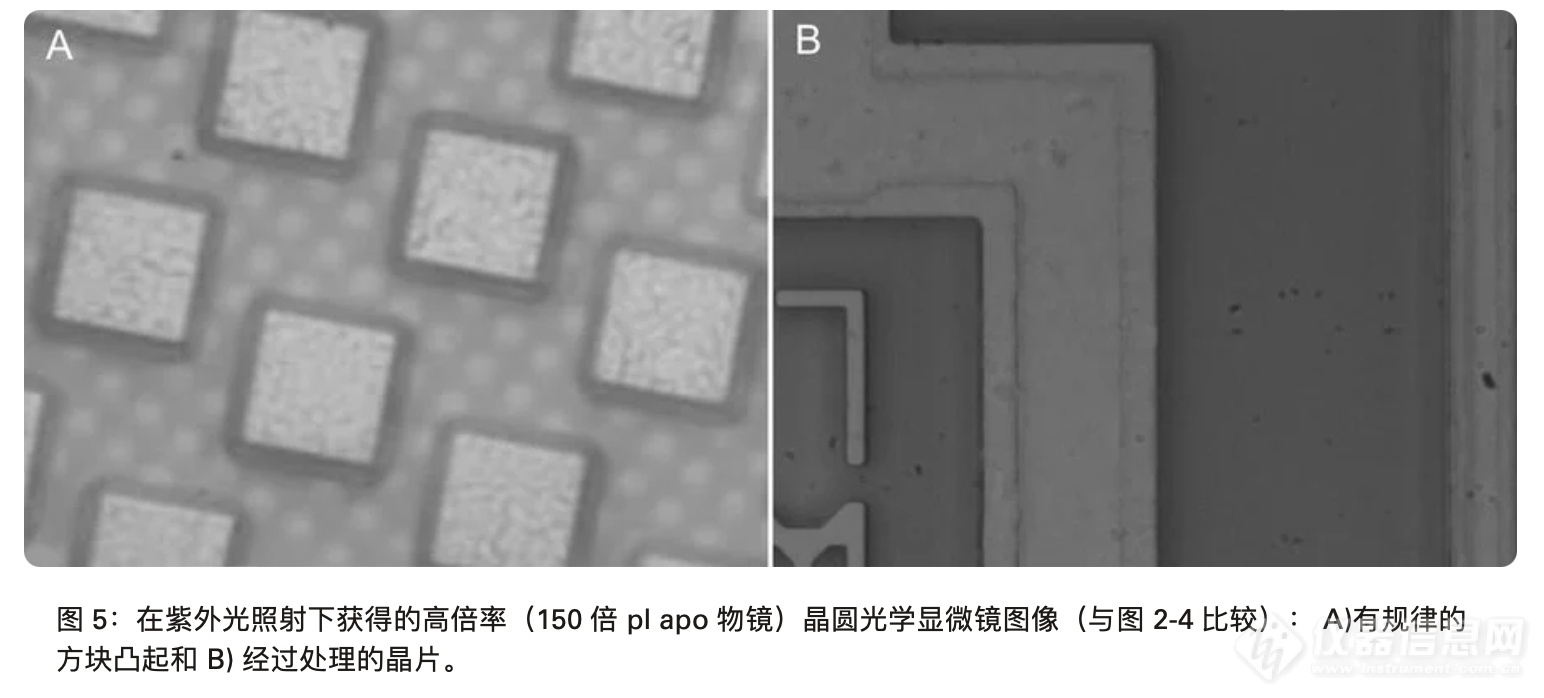
紫外成像不像上述其他对比方法那么常见,但它具有显著的优势 [2]。它利用入射紫外光的较短波长,实现了比可见光更高的分辨率 [2,5],并揭示了晶圆或半导体表面更精细的细节、结构和缺陷。使用白光进行 BF、DF、DIC 或 POL 成像时,这些小结构和缺陷并不总是清晰可见。使用可见白光(400-700 纳米)照明时,横向分辨率限制在 0.25 微米,使用紫外光(365 纳米)照明时,横向分辨率限制在 0.12 微米 [2]。用紫外光照明拍摄的晶片图像示例见图 5。
图 5:在紫外光照射下获得的高倍率(150 倍 pl apo 物镜)晶圆光学显微镜图像(与图 2-4 比较): A)有规律的方块凸起和 B) 经过处理的晶片。
斜照明是指使用入射可见光(BF)或紫外光,以斜角照射样品表面 [2]斜照明是指使用入射可见光(BF)或紫外光,以斜角照射样品表面[2]。图 6 显示了使用斜 BF 和紫外线照明拍摄的晶片图像示例。
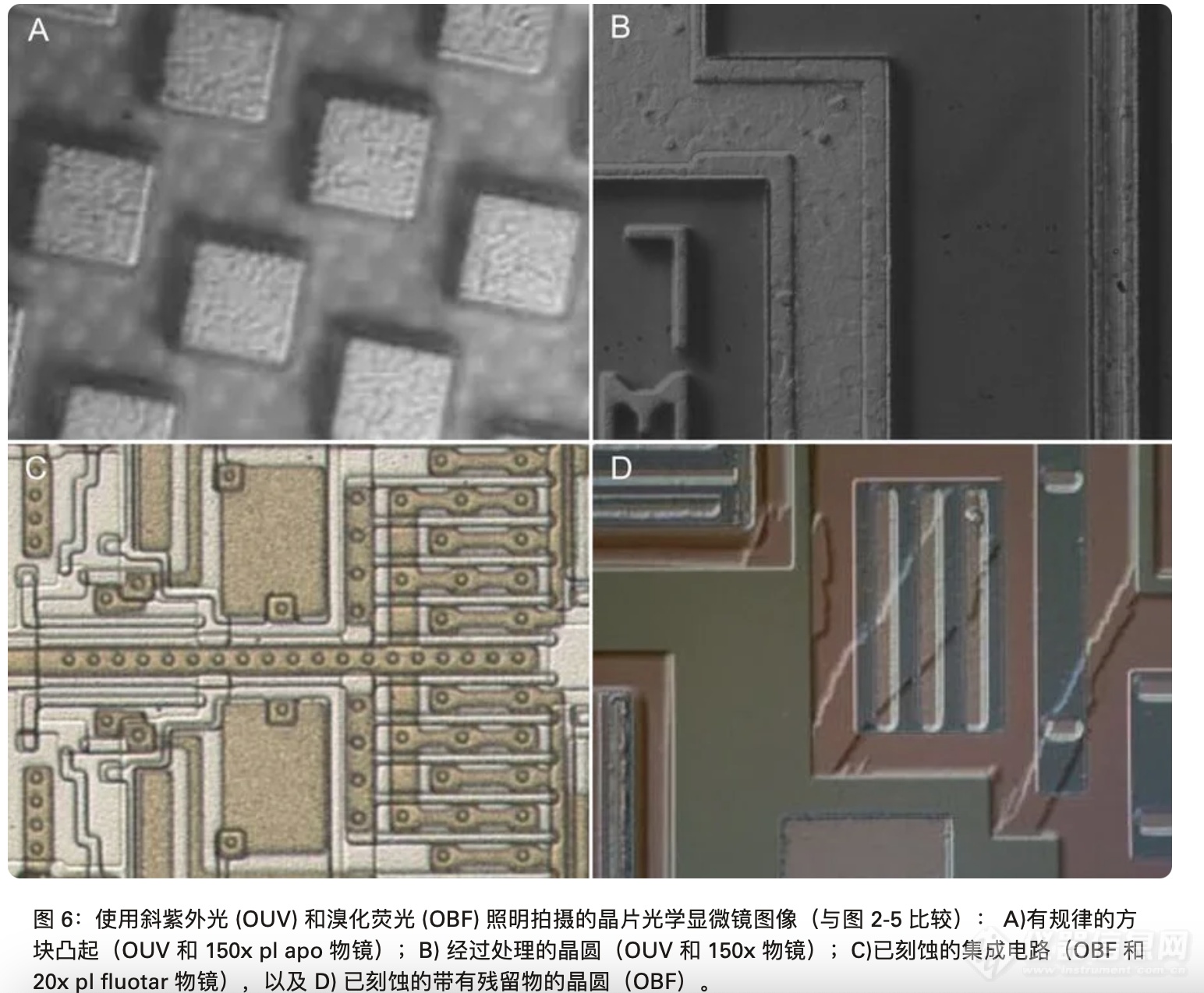
图 6:使用斜紫外光 (OUV) 和溴化荧光 (OBF) 照明拍摄的晶片光学显微镜图像(与图 2-5 比较): A)有规律的方块凸起(OUV 和 150x pl apo 物镜);B) 经过处理的晶圆(OUV 和 150x 物镜);C)已刻蚀的集成电路(OBF 和 20x pl fluotar 物镜),以及 D) 已刻蚀的带有残留物的晶圆(OBF)。
硅等半导体材料通常对红外(IR)光(波长为 1000 纳米或更大)是透明的。这意味着可以利用红外照明来观察晶片表面以下的细节,而这些细节在用可见光观察时是不可见的。因此,通过红外照明可以看到与表面下嵌入层相关的缺陷。图 7 是利用红外照明拍摄的晶片图像示例。
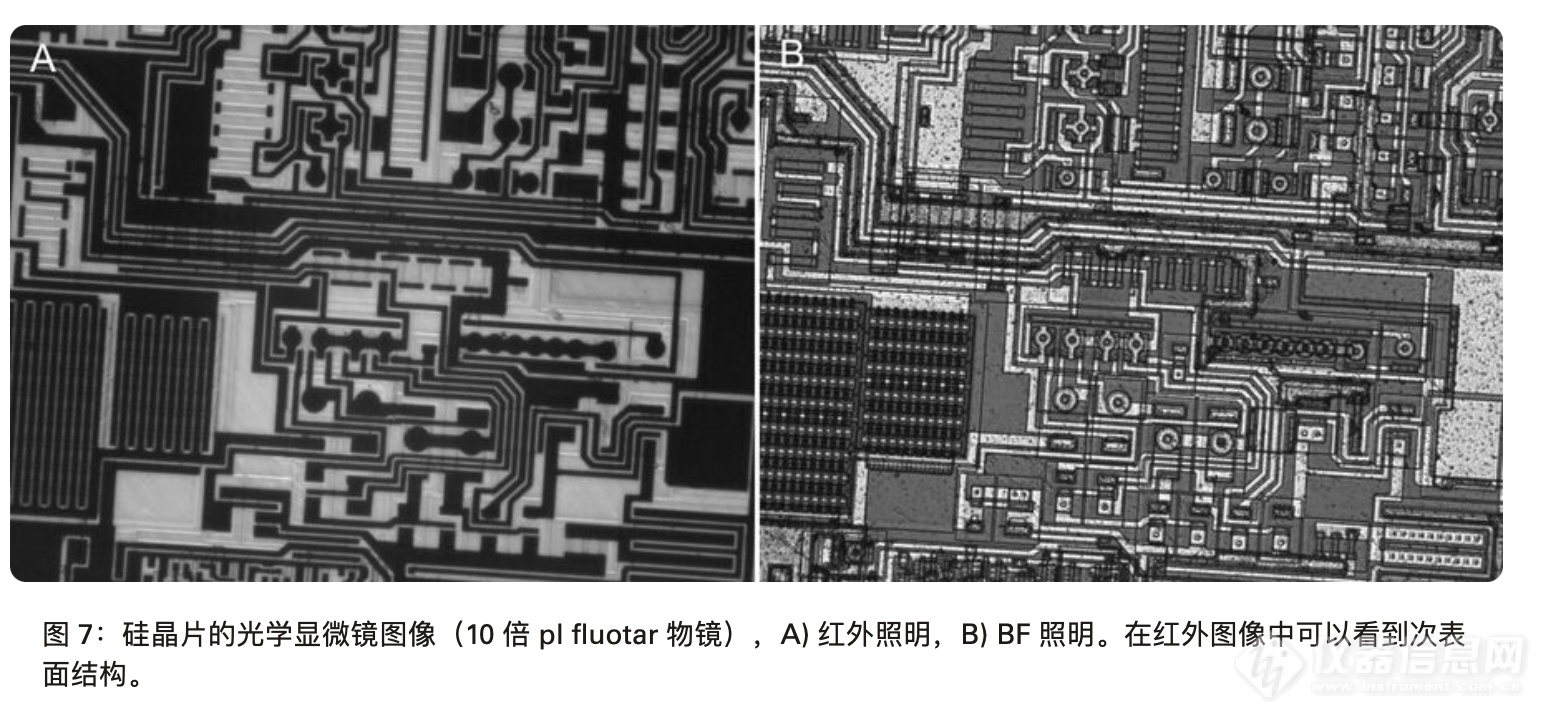
图 7:硅晶片的光学显微镜图像(10 倍 pl fluotar 物镜),A) 红外照明,B) BF 照明。在红外图像中可以看到次表面结构。
显微镜解决方案有助于克服检测难题
显微镜解决方案可提供多种(如果不是全部)上述观察方法,从而实现快速可靠的半导体、晶圆和微电子检测。上图 2 至图 5 所示的图像说明了观察方法和照明的改变是如何产生不同效果的。将 BF 与紫外线或斜照进行比较时,优势尤为明显(参见图2B 至 2D,以及图 5A 至 5F)。
徕卡显微镜解决方案可以帮助用户实现这一目标:DM8000 M 和 DM12000 M。它们提供所有 BF、DF、DIC、POL、UV 和斜照明观察方法,并使用户能够通过宏观到微观检测模式对样品表面的宏观到微观缺陷进行高效的主动筛选和检测。该模式可在 0.7x 至 150x 的放大倍率范围内轻松更换物镜(参见图 1、2A、3A 和 4A)。
摘要/结论
使用光学显微镜解决方案可以高效、准确地检测半导体材料、加工/刻蚀晶圆和集成电路芯片上的缺陷、结构和污染,该解决方案提供明场 (BF)、暗场 (DF)、微分干涉对比 (DIC)、偏光(POL)、紫外 (UV)、斜射和红外 (IR) 照明等对比方法。首先以低放大倍率和分辨率对样品进行快速扫描,以确定感兴趣的区域。然后,以高倍率和高分辨率检测和观察样品表面的细节、小结构、缺陷和污染。用户可以利用徕卡显微镜提供的这些观察方法。
参考文献
D. Dionis, J. DeRose, Section “Beyond brightfield” in Metallography - an Introduction: How to Reveal Microstructural Features of Metals and Alloys, Science Lab (2020) Leica Microsystems.
M. Doppler, How to Boost your Microelectronic Component Inspection Performance: Overcoming the resolution criterion - Webinar on-demand, Science Lab (2021) Leica Microsystems.
D. Dionis, J. DeRose, Section "Incident illumination contrast methods" in How to Adapt Grain Size Analysis of Metallic Alloys to Your Needs: Precise and practical microscopy solutions, Science Lab (2019) Leica Microsystems.
W. Ockenga, Polarization Contrast: An introduction, Science Lab (2011) Leica Microsystems.
M. Wilson, J. DeRose, C. Greb, Microscope Resolution: Concepts, Factors and Calculation: Airy discs, Abbe’s diffraction limit, the Rayleigh Criterion, and the point spread function (PSF), Science Lab (2023) Leica Microsystems.
下载本篇解决方案:
更多![]()
徕卡偏光显微镜DM4P在玻璃生产中的检测方案
徕卡偏光显微镜DM4P在玻璃生产中的检测方案如玻璃般清晰的质量——偏光显微镜在玻璃生产中的应用 精致美味的饮料应搭配***的玻璃杯。早在古罗马时期,人们便开始制作精美如艺术品的酒杯。在中世纪,威尼斯的玻璃制造商因其玻璃的纯净度而广为人知。作为已知的人类使用的*古老的材料之一,玻璃广泛应用于众多领域,而且无一例外均须满足*严格的质量标准。以光学显微镜为例,如果没有特殊类型的光学玻璃,就无法使用。为了保证平板玻璃、中空玻璃和压合玻璃的生产质量,偏光显微镜能够快速检测玻璃,而且能够实现良好的成本效益。晶体缺陷: 尽管硅酸盐玻璃在成分和属性上可能有很大的差异,但潜在缺陷类型和原因都很相似。除了气态夹杂物(气泡)外,结晶玻璃缺陷在日常生产中也很常见。 快速发现缺陷至关重要,这样才能确保采取适当的措施: 原材料和旧回收玻璃的耐熔污染物 未融化的原材料成分 冶炼厂的防火矿物材料的腐蚀残留物 脱硝产物
建材/家具
2024/05/16
徕卡M125C 汽车车身以及汽车部件焊接熔深检测方案
徕卡M125C 汽车车身以及汽车部件焊接熔深检测方案一、汽车焊焊接熔深的定义 汽车焊焊接熔深是指焊接接头的焊缝和母材之间的熔合区域深度。熔深是焊接焊接性能的重要指标之一。 二、汽车焊焊接熔深的测量方法 汽车二保焊焊接熔深的测量方法通常采用金相显微镜法或金相切割法。其中,金相显微镜测量法是通过显微镜观察试样经过切割、打磨、腐蚀等处理后的截面形貌,根据分界线的长度来确定熔深。金相切割法则是将试样切割成一定长度的薄片,用显微镜观察试样中心处的熔深,精度更高。 三、汽车焊焊接熔深的符号表示 汽车焊焊接熔深的符号表示为“a”,单位为毫米(mm)。在绘制焊接图时,箭头所指示的方向即为熔深方向,箭头两侧的a分别表示母材和焊缝的熔深。 四、汽车焊焊接熔深的要求和限制 国家标准《汽车焊接工艺规程》(QC/T 70-2015)规定了汽车焊焊接熔深的要求和限制。根据标准规定,汽车焊焊接熔深应满足以下要求: 1.焊接熔深的尺寸应符合设计要求,不能太小也不能太大。 2.焊接熔深的界限应清晰、明确,不得有锈蚀、气泡、裂纹等缺陷。 3.熔深的分布应均匀,不应出现局部过深或过浅的现象。 综上所述,汽车焊焊接熔深是衡量焊接接头质量的重要指标,标准化的测量方法和符号表示有助于确保焊接连接的质量和安全性。符合国家标准对汽车焊焊接熔深的相关要求和限制,能够有效地提高焊接接头的质量和可靠性。
汽车及零部件
2024/05/16
徕卡DM6M 铝合金铸件孔隙率检测方案
发动机与变速箱是汽车的核心部件,是产生动力与传动的部分,材料以铸铁、铸铝、铸锌为主。铸造产生的气孔是必要的检查项目。徕卡DM6M 铝合金铸件孔隙率检测方案, LAMOS APorosity是国内首创采用全自动显微镜检查压铸气孔的分析系统,全面支持VW50093/VW50097/VDG P202标准。 系统高度集成显微镜、摄像机、电动扫描台等硬件设备,自动扫描切面,自动拼接图像,选取基准面,孔隙分析,生成专业报告。
钢铁/金属
2024/05/16
徕卡DM4M DM6M新能源汽车零部件清洁度检测方案
影响汽车和电子制造业的高效清洁度分析过程的关键因素。徕卡清洁度检测仪DM4M在汽车和电子行业,零部件上细小的污染颗粒物也可能影响产品的性能,导致产品出现故障,或使用寿命缩短。对于汽车来说,过滤系统很容易受到影响。对于电子产品来说,印刷电路板(PCB)或连接器上的污染可能会导致短路。因此,清洁度在现代制造业的质量控制中占有核心地位,特别是使用由不同供应商生产的部件时,更要重点关注清洁情况。车辆或设备的关键部件如果受到污染,整个系统就可能发生故障。因此,高效清洁度分析过程必须始于供应商这一环。
汽车及零部件
2024/05/16













