理学XRT突破SiC晶圆缺陷表征效率瓶颈
自从我们通过不断发表理学XRT在半导体领域相关应用的文章使我们公司的XRT产品的百度搜索稳进前5之后,编者由于工作上事情比较多就开始懈怠近半年没有给大家带来最新XRT的资讯和相关应用介绍,先给关注这个产品的朋友道个歉。最近我们也获得理学总部关于这个产品的最新资讯,就迫不及待地分享给大家一睹为快。
1931年,第一张单晶的形貌图最早被Berg 记录下来。Berg 利用以一个极低角度的特征辐射照射单晶,在底片上得到了点对点变化的X射线反射形貌图,图中的条纹反映了晶体内存在塑性形变[1],从此推开了用X射线形貌技术表征晶体缺陷的大门。不同类型的晶体缺陷尺寸相差较大,唯有提高X射线形貌仪的分辨率和灵敏度才能准备获得缺陷尺寸和分布信息。所以诸多设备厂家和科研工作者一直致力于如何提高X射线形貌仪的分辨率和灵敏度。
与大多数成像设备类似,分辨率和灵敏度的提高基本是两个思路,第一个思路就是在保证X射线源光斑强度的前提下尽可能降低焦斑尺寸;第二就是通过提高X射线信号接收端的CCD探头的分辨率和灵敏度。理学XRT当前可以提供焦斑尺寸70μm高亮度射线源,从源头保证入射光束的均一性。同时该型号XRT具有超高分辨率和高灵敏度的XTOP CCD探头,可实现2.4um的像素分辨率成像,为更小位错缺陷的表征提供了可能。上述这一切的进步对于科研工作者是欢欣鼓舞的,但对于企业QC人员的帮助是有限的。企业应用场景除了仪器具备较为出色的性能之外,还要具备高吞吐量。理学公司急客户之所急,想客户之所想,针对SiC位错检测需求,研发人员在原有XRT技术基础上开发出了快速、准确和高效的位错解决方案,将关键技术指标BPD位错的检测效率提高5-6倍,1片6英寸SiC晶圆仅需要5min就可以完成样品测试,从而有效解决了SiC生产环节的瓶颈问题。
理学公司是如何实现快速、准确SiC位错缺陷的测试呢?理学公司将其在XRD中的高端二维陈列探测器HyPix-3000HE引进到XRT系统。HyPix-3000HE是一种单光子计数高的X射线探测器,计算率大于106cps/像素,读出速度快,基本上没有噪音。HyPix-3000实物安装图片及仪器特点参见如下:
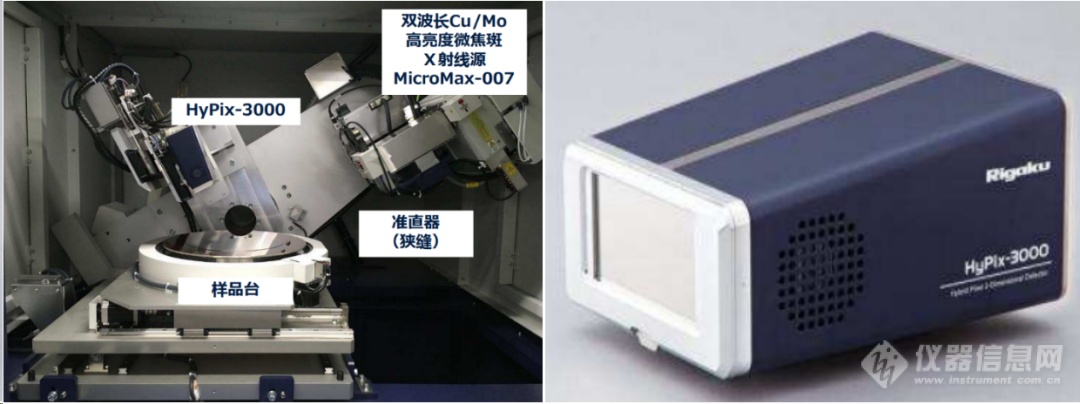
图2 HyPix-3000安装效果及实物图
HyPix-3000 HE探测器特点介绍:
・空间分辨率⾼,有效面积大。像素尺寸100×100µm2,探测面77.5 mm×38.5 mm;
・最大程度地降低背景;
・可进⾏零死时间模式的⾼速测量;
・动态范围广。
这套探测器除了上述本身固有的优点之外,搭载在理学XRT系统上最大好处就是对于X射线的入射光要求不再必须是平行光束,发射光束也可以用于晶圆缺陷的表征,从而省去XRT常规方案中布拉格衍射条件的调整和弯曲校正等调整流程。采用最小600mm/min的扫描速度,可以将1片6英寸晶圆的扫描用时从>60min降低到5min左右。图3为XTOP探测器方案和HyPix-3000HE方案示意图。

图3 XTOP方案和HyPix-3000HE方案示意图
带有HyPix-3000HE探测器的XRTmicron具有利用发散X射线成像,在使用HyPix-3000HE进行测量时,发射X射线以多种入射角照射到样品上,发散的X射线可以补偿由于晶圆倾斜,曲率半径变化和方位角等对平台的影响。例如,使用(11-20)反射模式测试一片直径150mm主面4°偏角的4H-SiC晶圆的形貌图,即使入射角度变化在±0.6°,参考边/Notch角度变化为±5°可以很好的成像,参见图4。
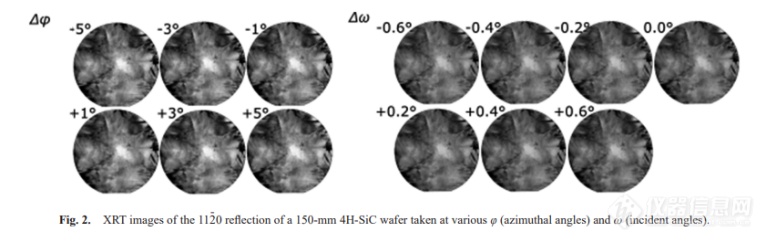
图4 调整入射角度下得到的XRT形貌图
介绍到这里有的朋友可能会有疑问,既然HyPix-3000HE探测器效率如此高,成像效果也不错,那为什么还要保留Xtop这个方案呢?那是因为前面我们也提到了HyPix-3000HE的成像分辨率是100μm,对于晶圆缺陷在100μm以上缺陷检测则不受影响,如BPDs这类缺陷,一般呈线状、平行于晶面方向。同时,BPDs缺陷对芯片外延的影响最大,所以也是企业客户重点关注的缺陷指标。对于TSDs和TEDs 由于尺寸均小于100μm,HyPix-3000HE探测器无法准确识别,仍需借助XTop (分辨率最高可达2.4μm)功能用于这类缺陷的表征。所以,对于企业客户我们一般建议在传统XTop的配置的基础上,升级HyPix-3000HE 功能和机械手操作用于快速QC检测,从而解决SiC晶圆缺陷表征环节的瓶颈问题。如下视频就是德国弗劳恩霍夫研究所采用理学HyPix-3000HE方案用于BPDs缺陷测试的视频[4],结合理学公司和德国弗劳恩霍夫研究所联合开发的形貌识别软件,实现SiC晶圆缺陷的高吞吐量的测试。
XRT测试过程
理学新一代微焦版转靶核心技术XRT形貌仪
XRT (X-ray Topography)是利用X射线的布拉格衍射原理和晶格畸变(缺陷)造成特征峰宽化和强度变化等特性,结合X射线形貌技术,可以对晶体内缺陷进行成像。XRT检测技术最大的优点就是实现晶体缺陷的无损检测,在不破坏晶圆的情况下实现2-12英寸半导体晶体中线缺陷、面缺陷和体缺陷的检测和表征。如下视频就是6英寸SiC衬底BPD缺陷测试。

XRT实物图
更多详细信息或应用需求请联系我们联系人:王经理,18612502188
附:
[1] 卢嘉倩,基于XRT的晶圆检测技术进展,中国体视学与图像分析2022年,第27卷,第 2期;
[2] 黄继武,X射线衍射理论与实践(I),2020年4月;
[3] 理学XRT应用介绍内部资料
[4]https://www.iisb.fraunhofer.de/en/research_areas/materials/x-ray-topography.html
更多![]()
日本理学东京研学之旅(上)
厂商
2024.03.05
XRT 在Ga2O3宽禁带半导体中的应用
厂商
2024.03.05
小角X射线散射和小角X射线衍射的区别!
厂商
2024.03.05
XRD的基本原理与应用
厂商
2024.03.05